
PrimaScan™ System
The PrimaScan wafer defect inspection system delivers a flexible, high sensitivity solution at the lowest cost of ownership per pass.
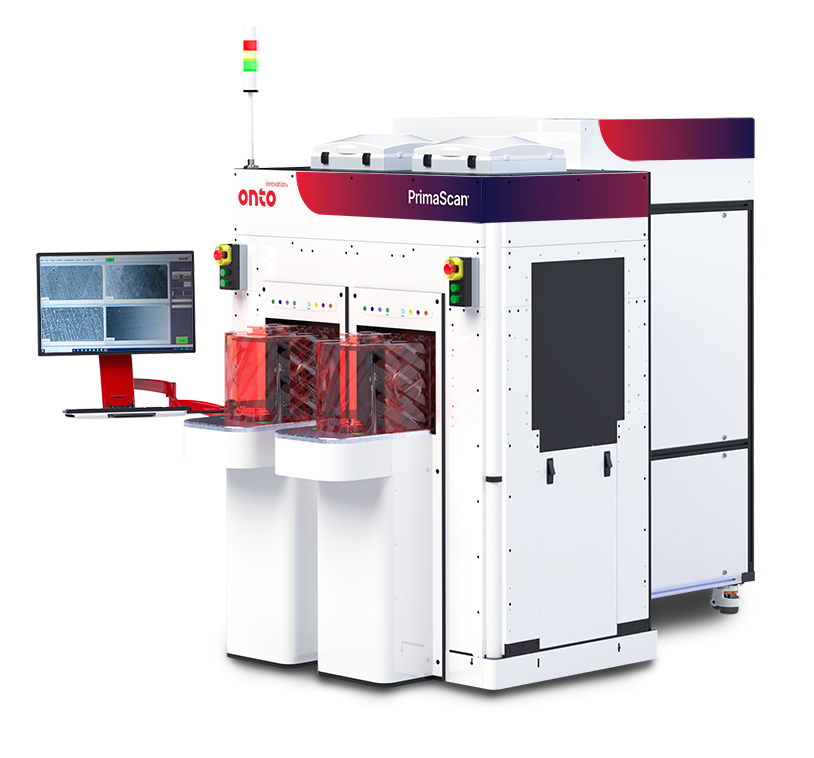
Product Overview
The PrimaScan system utilizes laser scatterometry and imaging techniques leveraging proprietary optics and sensing technologies for reliable inspection of nanometer sized defects on a variety of opaque and transparent/semi-transparent substrates suitable for either R&D or high-volume manufacturing environments. With multiple detection channels, the system can detect, measure, characterize and image surface particles, scratches, pits, bumps, surface contamination, film or bulk wafer stress, voids/inclusions, including chips and cracks at the wafer edge.
The PrimaScan system addresses challenges in both incoming wafer quality control and in inline process monitoring. Capable of handling multiple substrate materials, it uniquely addresses inline process defect and contamination monitoring in wafer-based production environments.
Designed with versatility in mind the PrimaScan system can handle a variety of wafer sizes and substrate types
Applications
- Opaque or transparent wafer incoming quality (ICQ) inspection
- Process monitor wafer particle and contamination inspection
- Unpatterned blanket photoresist, dielectric or metallic coated wafer defect inspection
- Subsurface defectivity inspection for transparent and semi-transparent films and substrates
- Glass carrier wafer defect and contamination inspection for advanced packaging
- Glass wafer defect and contamination inspection for microfluidics, microlens arrays for AR/VR/MR, flat optics, etc.

Do you have a PrimaScan system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Heterogeneous integration is a key enabler of today’s AI innovations. By bringing together multiple chips with different functionalities, a.k.a., chiplets, AI devices have been able to achieve tremendous performance gains. However, the heterogeneous integration of advanced packages has its own set of process control obstacles that must be addressed, including new interconnect challenges involving redistribution layers (RDL) and bond pads.
Recently, Onto Innovation and Samsung Electronics Co., Ltd., teamed up to explore how picosecond ultrasonic technology could be used to measure the metal thickness of RDL and bond pads in high performance AI packages. In this blog, the second in our series on the advanced packaging applications of picosecond ultrasonic technology, we will show how this technology can be used to measure metal films during RDL and bond pad processes.
But first, a word about picosecond ultrasonic technology, a widely adopted non-contact, non-destructive acoustic technique that can be used to measure film thickness.
Measuring Films
Picosecond ultrasonic technology measures film thickness by tracking the round-trip travel time of ultrasonic waves generated and detected using an ultrafast laser pump probe technique. A short laser pulse (pump) creates an acoustic wave that travels through the film, reflects at material interfaces, and returns to the surface. A second laser pulse (probe) detects the returning wave.
Two detection methods can be used to determine film thickness or properties:
- REF mode senses changes in surface reflectivity caused by the returning wave.
- PSD mode detects surface deformation by measuring shifts in the reflected probe beam.
By measuring the time it takes for the wave to return and knowing the speed of sound in the material, the film thickness can be accurately determined to sub-angstrom levels.
This level of layer-specific metrology, precision, and measurement repeatability is increasingly critical as AI-driven packaging pushes the limits of interconnect density and uniformity.
Accuracy and Repeatability
For the purpose of our exploration, we conducted a test to confirm the accuracy of picosecond ultrasonic technology when measuring the films typically used in advanced packaging. These metals include Au, Ni, physical vapor deposition (PVD) seed Cu, and RDL Cu (EP). For each film we used picosecond ultrasonic technology to measure wafers of varying thicknesses. Then we cut the wafers for cross-section analysis and estimated the correlation with the picosecond ultrasonic results for the four films (Figure 1). In this scenario, the correlation factor R2 was higher than 0.99 for all four cases, with the slope close to one, demonstrating the accuracy of picosecond ultrasonic measurements.
This level of correlation is not only impressive, it is essential. Competing technologies such as four-point probe (4PP) or contact profilometry often fall short in multilayer structures or non-planar surfaces, where mechanical contact can distort results or damage delicate features.
Following this, we measured product wafers in various interconnect processes with picosecond ultrasonic technology, including seed Cu/Ti measured in REF mode (Figure 2) and RDL in PSD mode (Figure 3). RDL thickness can be measured both in pre- and post-seed Cu removal.



The horizontal axis in Figures 2 and 3 represents the time delay of the probe pulse with respect to the pump, while the vertical axis represents the change of reflectivity (ΔR/R) caused by the travelling acoustic wave. The sharp change of reflectivity in the signal, as demonstrated in Figures 2 and 3, is mostly due to the acoustic wave reflected from the film interface returning to the surface. In addition, the position of the peak and trough is shown with red arrows. These arrows are directly related to the thickness of the films, seed Cu, barrier Ti, and EP Cu. From the position of the peak and trough, the thickness of each film can be calculated. For seed Cu and barrier Ti, the repeatability of each layer is 0.3% or less of the thickness for all measurements. This demonstrates the capability of picosecond ultrasonic technology to meet 10% gage repeatability and reproducibility requirements.
For RDL Cu, the sharp change of reflectivity near 2,200 picoseconds (ps) corresponds to the round-trip time of the acoustic wave within the RDL Cu film; Cu thickness can be calculated from the trough position. The sharpness of the trough, along with thickness, indicates the trough position can be calculated with good repeatability. In fact, the repeatability of RDL Cu measurements for each point is less than 0.1% of Cu thickness, once again exceeding the 10% gage repeatability and reproducibility requirements.
Such precision is a necessary technical achievement. As AI applications demand tighter control over signal integrity and power efficiency, the margin for error in interconnect thickness shrinks dramatically. Legacy tools simply cannot keep up.
Measuring Bond Pads with Dimple Structures
We also used picosecond ultrasonic technology to measure a bond pad with a dimple structure. The film stack is composed of Au/Ni/Cu, with Au being the top film. Although the height of the center region of the pad is lower than the surrounding region by a few microns, we successfully measured individual layer thicknesses by measuring a few sites in the outer ring area and selectively choosing ones with good signal-to-noise ratios. This is possible because the focused spot size of the picosecond ultrasonic beam is 8×10µm2, small enough for the direct measurement on the outer ring of the pad.
This is another area where contact-based methods struggle. The ability to selectively target small, non-planar regions without physical interference is a key differentiator of picosecond ultrasonic technology.

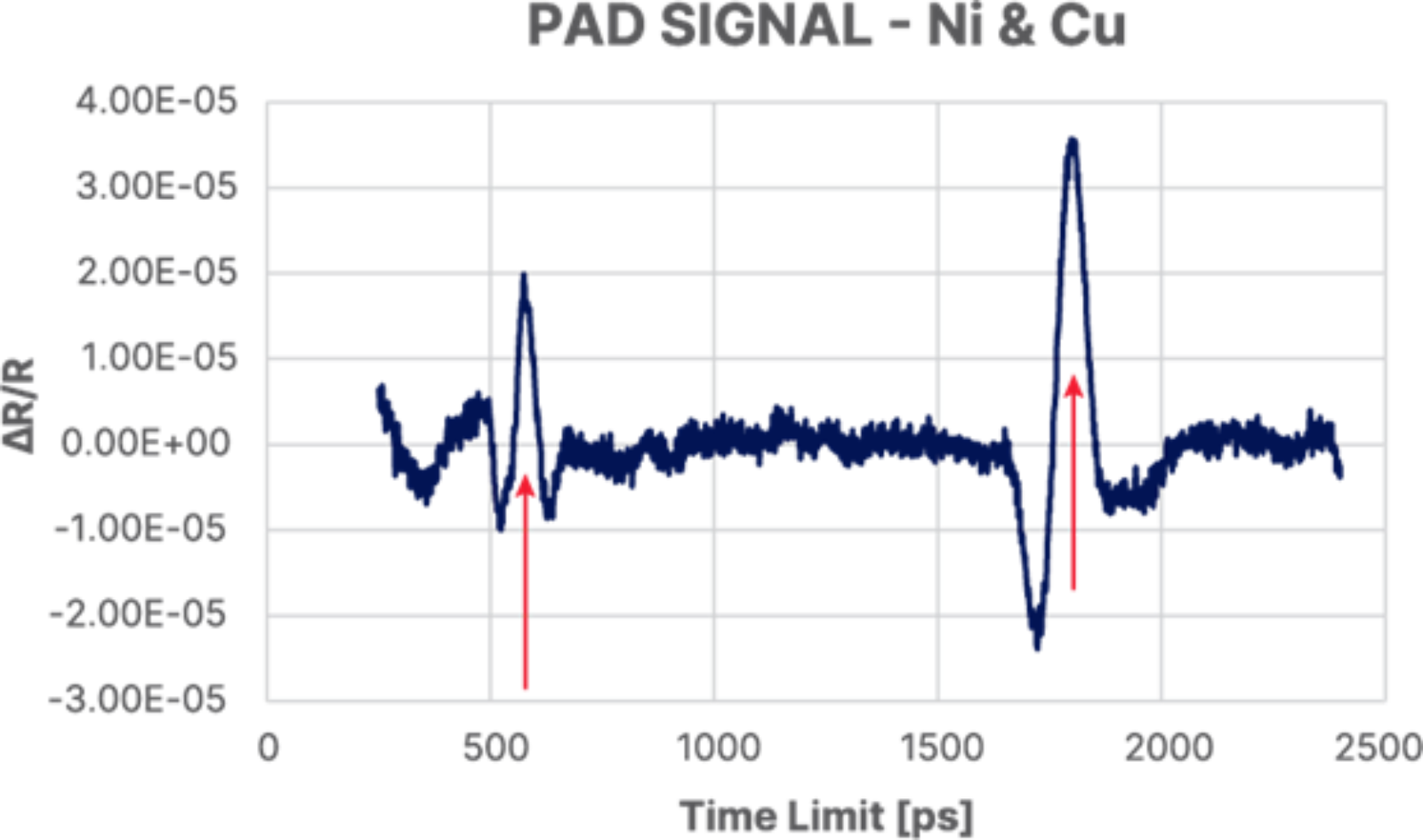
In Fig. 4 a-b, the red arrows indicate the reflectivity changes caused by the acoustic waves returning from the interface to the surface. With these peak positions, we were able to calculate each layer’s thickness with good accuracy and repeatability. The repeatability of Au, Ni and Cu films for each measurement was less than 0.2%, 0.05% and 0.05%, respectively. As such, all three film measurements outperformed the requirement of 10% gage repeatability and reproducibility.
It should be noted that Au film is much thinner than the other two films. As such, there is a significantly higher repeatability for Au films compared with the other films.
Conclusion
The AI era is upon us, and it would not be possible without advanced packaging innovations. However, the complexity of today’s advanced packaging is worlds away from traditional packaging. Today’s back-end process involves a variety of technologies and requires new methods of process control. In addition, controlling metal thickness and within wafer uniformity in these processes is critical to meeting the requirements for signal integrity in advanced packaging.
Unfortunately, some fabs still rely on legacy metrology tools like 4PP or contact profilometry—technologies that were never designed for the complexity of modern AI packages. These tools often introduce mechanical stress, lack the resolution to resolve thin or buried layers, and cannot reliably measure non-planar or dimpled structures.
As we have demonstrated, picosecond ultrasonic technology is an ideally suited interconnect metrology solution for both RDL and bond pads. This technology offers excellent accuracy and gage capability for the control of interconnect processes in advanced packaging.
As back-end processes demand the same level of precision, uniformity, and control traditionally associated with front-end requirements, picosecond ultrasonic technology can play a major role in advanced packaging metrology, delivering the non-contact, high-resolution, and repeatable measurements that AI applications demand.
Acknowledgments
We would like to thank Dae-Seo Park, Sanghyun Bae, Junghwan Kim, and Hwanpil Park of Samsung Electronics Co., Ltd., and Kwansoon Park, G. Andrew Antonelli, Robin Mair, Johnny Dai, Manjusha Mehendale and Priya Mukundhan of Onto Innovation for their contributions to this article.
About the author
Cheolkyu Kim, Ph.D., is director of product marketing at Onto Innovation with a focus on application development for picosecond ultrasonic (PULSE™) and inspection technologies. Prior to joining Onto, Kim was a postdoctoral research associate in the Physics Department of Brown University. During his three years at Brown, he spent time researching magnetically levitated superfluid liquid helium.
The 75th anniversary celebration of ECTC in Dallas showcases a remarkable evolution in advanced packaging technologies, revealing how semiconductor priorities have dramatically shifted. Rather than the relentless miniaturization of the smartphone era, today’s AI-driven applications demand larger packages with more functionality and sophisticated thermal management solutions.
Glass core substrates emerged as the star technology of the conference, with standing-room-only sessions demonstrating the industry’s intense interest in this promising material platform. The excitement is justified – glass offers superior dimensional stability and enables higher-density interconnects than traditional organic substrates. Meanwhile, co-packaged optics generated similar enthusiasm as engineers tackle the monumental challenge of powering AI server racks that consume between 0.5-1 megawatt each, making energy efficiency a critical concern.
The conversation with Onto Innovation’s Monita Pau begins at 1:10.
Yield Optimizer™ Software
Yield Optimizer software is part of a comprehensive next-level data management portfolio. It reimagines manufacturing line control and analytics to explore the impact of previously invisible factors in day-to-day factory operation.
Product Overview
Yield Optimizer software is the next incarnation of analytics on the evolutionary scale. The software’s disruptive technology analyzes relationships between multivariant data and their complex interactions. By examining any set of conceivable inputs and outputs, Yield Optimizer software identifies the relationships and interactions that lead to positive operational changes. Easily understood visuals empower even casual users to understand what is important before making adjustments.
Yield Optimizer software evaluates multiple models and suggests the best one for the data. Using machine learning, it examines the interactions between in-process metrology readings and end-of-line test results for any semiconductor product family and recommends changes to the in-process metrology targets. When licensed as a service, it enables users to leverage an on-demand infrastructure to apply easily understood workflows for complex analytics without the overhead.
Applications
- Yield Prediction
- Process Targeting
- Design of Experiment (DOE) Assistant
- Troubleshooting
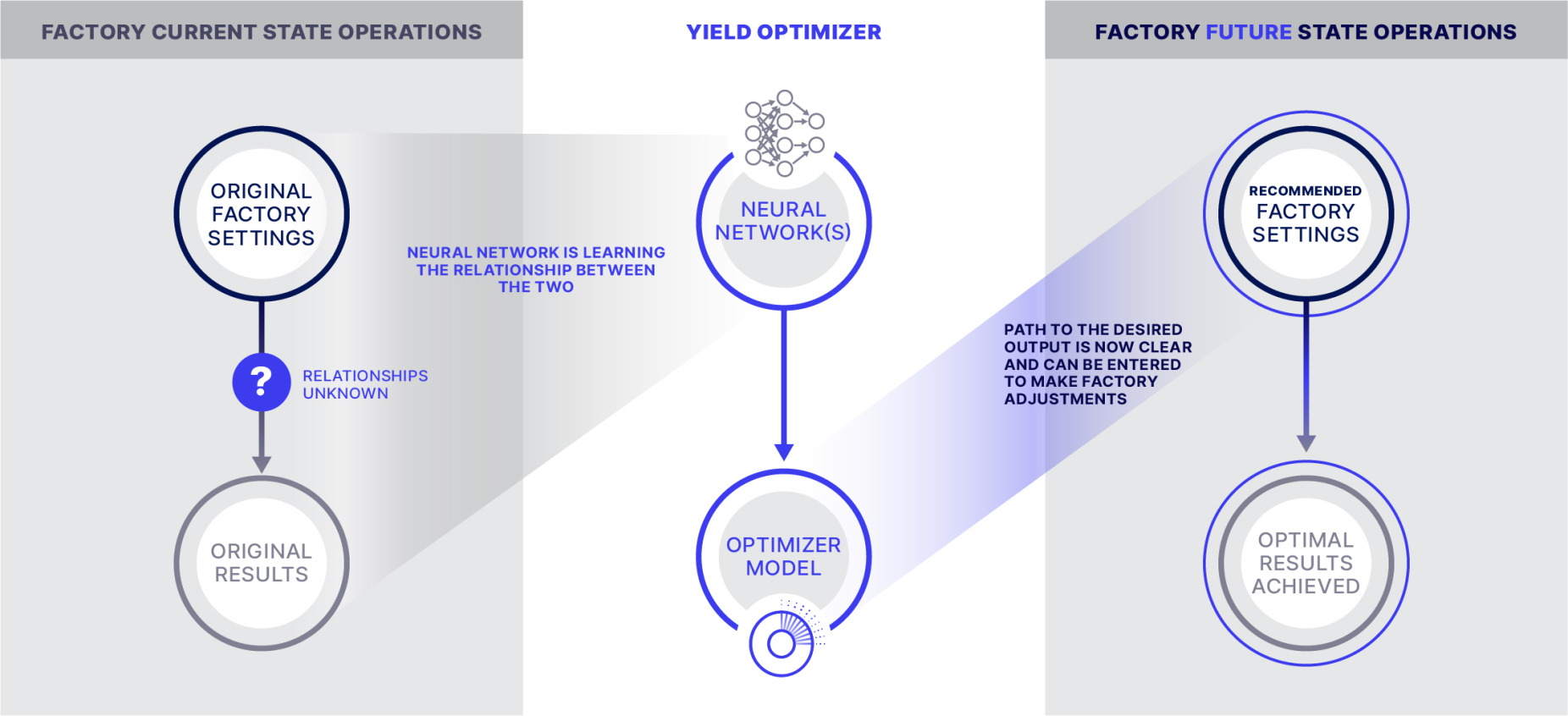
Neural networks model today’s data to achieve tomorrow’s in-line targets

Users across the fab benefit from Yield Optimizer software’s easy-to-apply analytics

Do you have a Yield Optimizer software question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
TrueADC® Software
TrueADC software enhances defect classification accuracy and efficiency by combining deep learning, real-world defect modeling, and intuitive workflows—reducing manual review and improving decision-making across all wafers and surfaces.
Product Overview
TrueADC software sets a new standard in defect classification by combining advanced analytics with intuitive usability. Seamlessly integrated with Onto Innovation’s AOI tools and Discover platforms, TrueADC software enhances inspection value through a proprietary hybrid decision-making process across all wafers and surfaces.
With over 70% reduction in manual review, TrueADC software intelligently flags low-confidence defects as “unknown” to avoid misclassification. Its dynamic defect library method uses real defect examples—unlike traditional ADCs that rely on approximations—delivering more accurate and efficient results.
Supporting adder, repeater, SPR codes, and region-of-interest data, it enables precise tool sampling and binning. Operators can quickly classify new defects without altering recipes, while the software’s multi-engine mode leverages deep learning to reduce overkill and underkill.
From model development to identifying hard-to-isolate defects, TrueADC software empowers engineers with greater clarity, control, and confidence.
Applications
- On-tool with Onto AOI systems
- Inline defect classification
- Dynamic defect library utilization
- Support for advanced defect types

Do you have a TrueADC software question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Discover® Patterns Software
Discover Patterns software quickly and easily traces patterns back to yield-killing process issues.
Product Overview
Discover Patterns software combines sort and defect spatial patterns utilizing proprietary machine learning (ML) algorithms, to uncover hidden patterns that would have been otherwise lost. Segmentation allows users to eliminate noise and extract definitive patterns from a larger pattern or a seemingly random array of defects. Wafer stacking enables the handling of faint defect trends to more clearly isolate patterns.
Combining Discover Patterns software with the Discover Defect platform multiplies the value of your defect management infrastructure by intelligently identifying and acting upon known patterns in real time. It marks defects and die affected by patterns for deeper understanding of processes and reduces the need for human intervention.

Highlight all patterns, not just the dominant ones
Applications
- Memory
- Logic
- Foundry
- Compound-Semi
- LED
- Advanced Packaging

Do you have a Discover Patterns software question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields