JetStep® X500 System
The JetStep X500 system is designed to provide AICS and OSAT manufacturers with a high-volume manufacturing lithography solution for heterogeneous integration. The JetStep X500 system exposes panel-type substrates made of CCL, FR4, composite, glass or other materials.

Product Overview
The JetStep X500 panel lithography system is optimized for high volume manufacturing of high-end AICS and other advanced packaging panel applications. As we approach the limits of Moore’s law, the JetStep X500 system addresses the need for extremely large packages integrating multi-node chips, or “chiplets,” enhancing functionality, speed, I/O count and reducing power consumption for server farms, AI, and mobile applications. The JetStep X500 system features the industry’s largest exposure field , fine line RDL resolution with large depth of focus (DOF), excellent overlay accuracy, and automatic magnification compensation with independent x and y magnification adjustment. The JetStep X500 system handles a large range of substrate thicknesses with high levels of warp, offering unique imaging parameter control to compensate for panel distortion. Additionally, it can run highly warped substrates with an edge clamping option and provides real-time autofocus at every exposure site to compensate for challenging topography.
Applications
- AICS
- Fan-out panel level packaging (FOPLP)
- Large package formats, exposed without stitching
- Large interposers
- Redistribution layer (RDL) / underbump metallization (UBM)
- Vias in photo imageable dielectric (PID)
Featured Markets


Adaptive Shot Lithography Solution
Die shift on reconstituted panels can significantly impact both productivity and yield. To address this challenge, we use a parallel die placement measurement process and advanced analytics to provide a means to balance productivity against yield. Our integrated lithography cell, featuring Firefly inspection, StepFAST software, and JetStep Lithography, delivers industry-leading throughput and yield for fan-out panel level packaging.
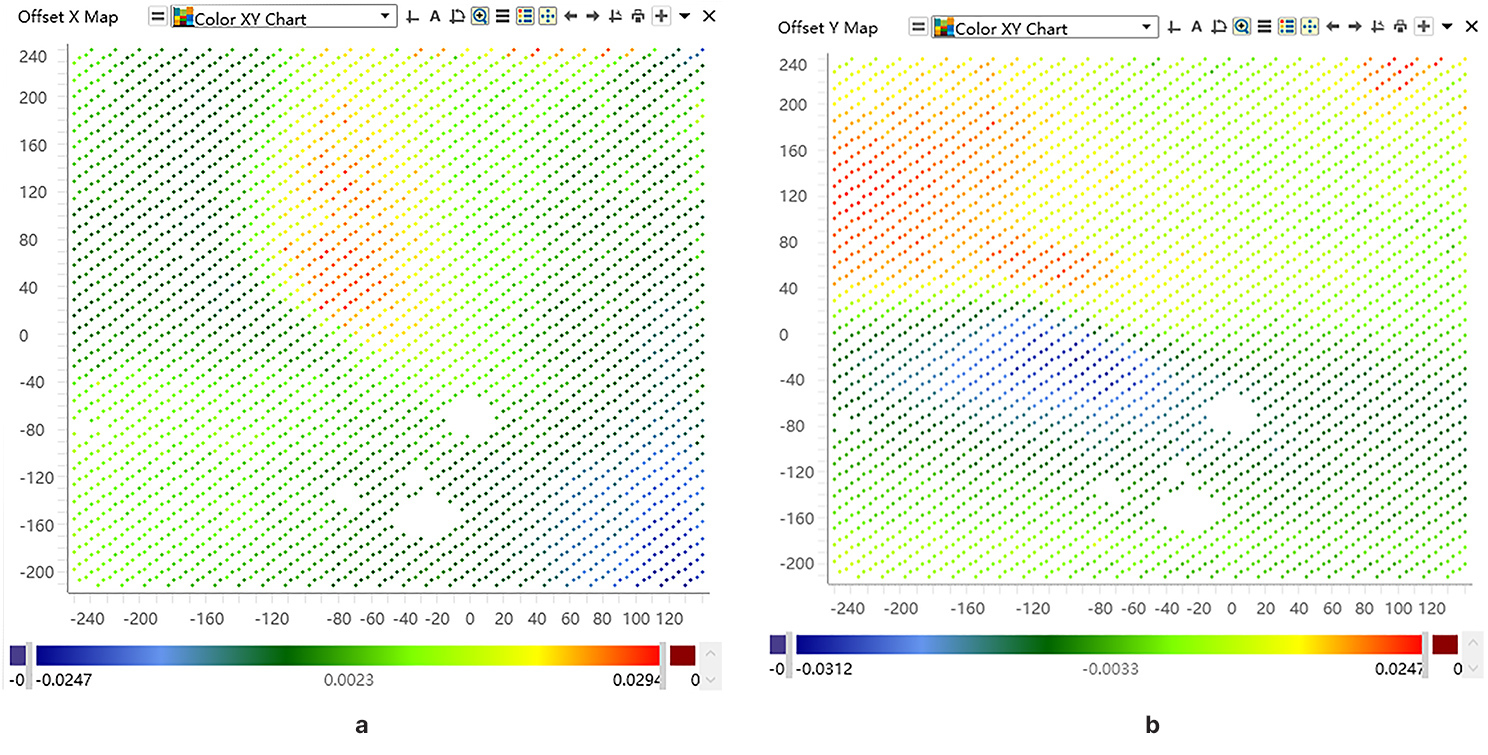
Overcoming FOPLP Die Placement Error
It is well understood that advanced packaging applications require high performance, low cost, increased functionality and improved reliability that 2.5D and 3D packaging solutions provide. Fan-out panel-level packaging (FOPLP) is one of the technologies that has the potential to meet these packaging requirements.
Adaptive Overlay Control
During the processing of organic (CCL) advanced IC substrates (AICS) the substrates become distorted which impacts the overlay of Via to RDL pad structures. To solve this problem, the stepper must adjust the alignment solution to match the previous layer’s distortion by measuring the overlay. Proprietary software provides the user with the ability to adjust each zone of the AICS with independent offsets.
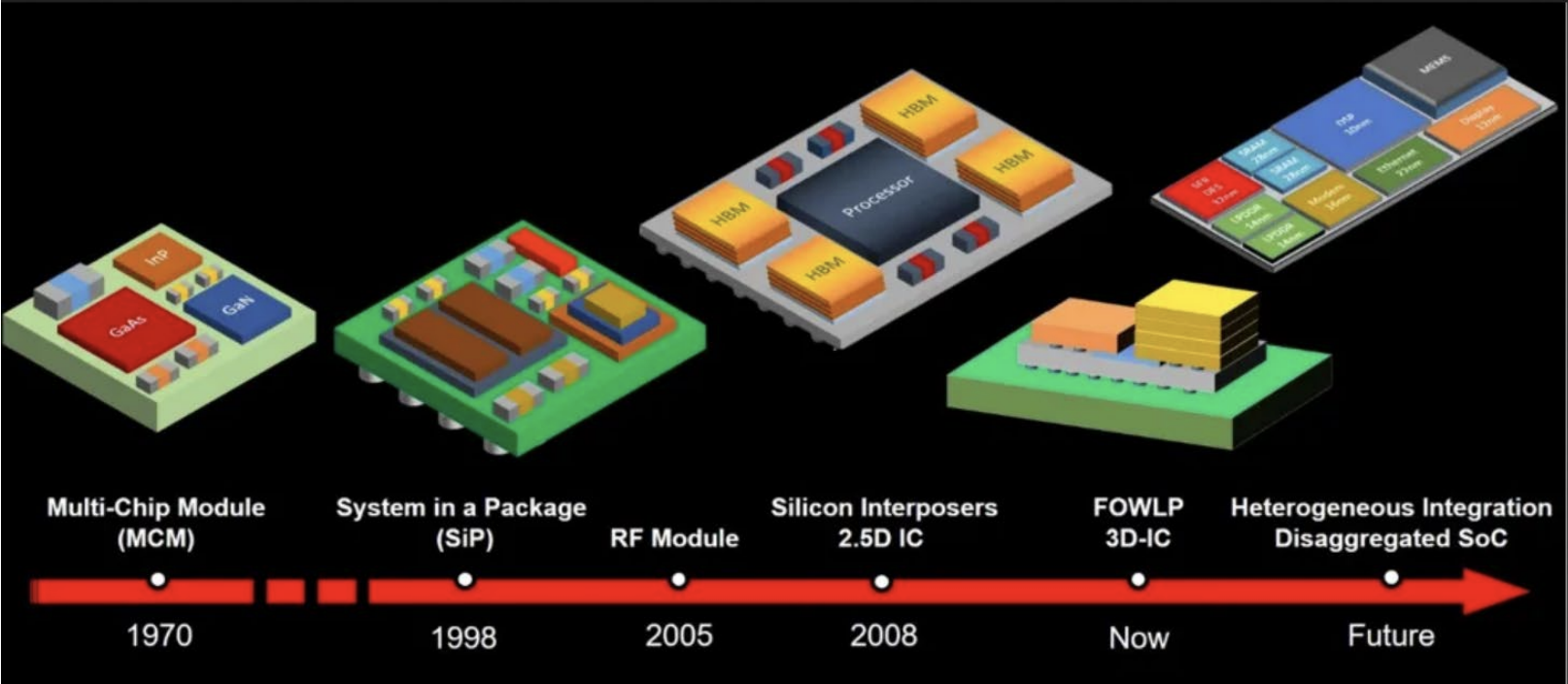
Analysis of Pattern Distortion by Panel Deformation
The growing demand for heterogeneous integration is driven by the 5G market. This includes smartphones, data centers, servers, high-performance computing (HPC), artificial intelligence (AI) and internet of things (IoT) applications. Next generation packaging technologies require tighter overlay to accommodate larger package sizes with fine-pitch chip interconnects on large-format flexible panels.

Do you have a JetStep X500 question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields