
If you’ve been following the evolution of advanced packaging, you know that the industry is pushing boundaries like never before. From high-performance computing to industry-upending AI devices, the demand for smaller, faster, and more powerful chips is driving innovation at every level. One of the unsung heroes in this transformation: Glass carriers.
These carriers are becoming essential for applications involving high-bandwidth memory (HBM), 2.5D/3D integration, and chiplet architectures. During the manufacturing process, glass carriers serve as mechanical support for thin wafers and panel-level packages. Why? Glass carriers are noted for their warpage resistance, superior rigidity, and thermal stability. This combination of glass’ exceptional flatness and rigidity enables the precise placement of dies and interposers. Additionally, glass is optically transparent, which allows through-glass alignment during bonding and stacking, a critical capability for 3D integration where multiple layers must be accurately registered.
The benefits of glass carriers, however, come with several challenges, none of which should come as a surprise to anyone who has ever handled glass, whether in the fab or at home. Glass is fragile and, as such, is prone to surface defects, subsurface inclusions, and residual stress. Each of these can negatively impact die attachment quality, interconnect reliability, and die yield.
Let’s take a look at three major yield-killing culprits.
Surface defects such as particles, pits, and scratches are among the most common issues and may occur during glass carrier handling and processing, compromising the structural integrity and performance of advanced packaging assemblies (Figure 1). Particles can interfere with the bonding process, leading to poor adhesion or electrical discontinuities, while pits and scratches can propagate stress points that weaken the carrier during thermal cycling or molding.
However, subsurface inclusions and organic contamination, which are often introduced during reclaim or cleaning, pose more critical challenges. Inclusions within the glass can create localized stress concentrations, while organic residues can reduce UV transmission and cause bonding failures. These contaminants are particularly problematic in high-density interconnect environments where optical clarity and surface purity are critical.

Figure 1: Common glass carrier defects
In addition to surface and subsurface defects, residual stress represents a concern. Over time, these stress points, manifesting during thermal processing or mechanical handling, can lead to cracks or delamination, undermining the thermo-mechanical integrity of the entire package.
These potential challenges are compounded each time a glass carrier is reused in an effort to reduce overall packaging costs. Fortunately, technologies have been developed to address this obstacle. These technologies integrate AI-driven defect classification, real-time analytics, and adaptive scanning modes to maintain throughput without sacrificing accuracy, enabling manufacturers to detect surface anomalies, subsurface inclusions, and stress-induced defects with unprecedented precision.
Enabling Defect-Free Glass Carriers
Today’s wafer-based inspection platforms utilize laser scatterometry and imaging techniques to inspect for nanometer sized defects on a variety of opaque and transparent/semi-transparent substrates. These substrates may be suitable for either R&D or high-volume advanced IC substrate (AICS) and fan-out panel level processing (FOPLP) environments. Proprietary inspection technology with multiple detection channels and advanced signal processing algorithms is applied to achieve accuracy and reliability in glass carrier inspection.

Figure 2: Results of top (blue) and bottom (red) defect mapping.
With each channel optimized to capture unique scattering and reflection signatures, the technology differentiates between surface and subsurface defects, as well as stress-related anomalies, with remarkable accuracy. Surface particles, scratches, pits, bumps, surface contamination, film or bulk wafer stress, voids/inclusions can be detected, measured, characterized, and imaged. One of the most significant capabilities of this technology is the ability to conduct simultaneous top, bottom, and internal defect mapping, a critical need for transparent and semi-transparent substrates where defects can occur across multiple planes (Figure 2).
Beyond defect detection, Angstrom-level film thickness measurement provides precise control over surface coatings and residual layers. This capability is particularly valuable in the glass reclaim process where even minor variations in film thickness can impact UV transmission and bonding performance. By enabling accurate defect detection and grading, only glass carriers meeting stringent quality standards are returned to production.
By introducing technologies that mitigate risks by providing comprehensive defect mapping and stress analysis, manufacturers are able to maintain the mechanical and thermal integrity required for next-generation devices. This capability is especially valuable in markets such as AI devices, high-performance computing, and automotive electronics where reliability is non-negotiable. With this combination of advanced optical technology and robust algorithmic analysis, manufacturers can successfully achieve higher yields, lower costs, and greater confidence in their packaging processes.
Conclusion
As packaging complexity grows and the use of glass carriers increases, inspection systems that combine multi-depth defect mapping and stress analysis will become indispensable for ensuring yield and reliability in AI and HPC devices. With the explosive growth in AI-driven data centers and advanced packaging architectures, manufacturers need solutions that combine accuracy, speed, and cost efficiency. The laser-based wafer inspection technology discussed in this blog meets several glass carrier challenges head-on while enabling advanced packaging houses to maintain defect-free glass carriers in support of next-generation advanced packaging.
The future of glass carriers is clear: with the right technologies at the ready, manufacturers have the tools and the means to meet the growing needs of the AI and HPC markets.
Biography
Jason Lin is Director of Product Marketing at Onto Innovation.

You Have a Challenge? Let’s talk.
We’d love to connect with you.
Looking to learn more about our innovative solutions and capabilities? Our team of experts is ready to assist you. Reach out today and let’s starts a conversation about how we can help you achieve your goals.
Let’s Talk
"*" indicates required fields
FAaST® CV/IV System
The FAaST system is a versatile, non-contact electrical metrology platform, with an option to combine micro and macro corona-Kelvin technologies together with digital surface photovoltage (SPV). It enables high-resolution dielectric and interface measurements across a wide range of dielectric materials, supporting both R&D and high volume manufacturing.

Product Overview
The primary application of non-contact CV metrology is monitoring dielectric properties during IC manufacturing. Unlike conventional electrical measurements, it requires no sample preparation, eliminating the need for MOS capacitor structures. This reduces metrology cost and enables fast data feedback in both R&D and manufacturing environments.
The corona-Kelvin method uses a corona discharge in air to deposit an electric charge (DQC) on the wafer surface. A vibrating Kelvin-probe then measures the resulting surface voltage (V), enabling determination of the differential capacitance (C= DQC/DV). By monitoring surface voltage in both dark and illuminated conditions, the system separates two key components: dielectric voltage (VD) and semiconductor surface potential (VSB), enabling determination of flat band voltage (VFB).
Analysis of the resulting charge-voltage data yields electrical parameters, including trap density (Dit), flat band voltage (Vfb), dielectric charge (Qtot), dielectric capacitance (CD), Equivalent Oxide Thickness (EOT), leakage current, and tunneling characteristics.
Applications
- Plasma damage monitoring
- Residual charge and non-visual defect inspection
- Diffusion furnace oxide and interface characterization
- High-K and low-K dielectric capacitance
- Mobile ion mapping
- Charge trapping and hysteresis
Featured Markets

Do you have a FAaST CV/IV system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
JetStep® X500 System
The JetStep X500 system is designed to provide AICS and OSAT manufacturers with a high-volume manufacturing lithography solution for heterogeneous integration. The JetStep X500 system exposes panel-type substrates made of CCL, FR4, composite, glass or other materials.

Product Overview
The JetStep X500 panel lithography system is optimized for high volume manufacturing of high-end AICS and other advanced packaging panel applications. As we approach the limits of Moore’s law, the JetStep X500 system addresses the need for extremely large packages integrating multi-node chips, or “chiplets,” enhancing functionality, speed, I/O count and reducing power consumption for server farms, AI, and mobile applications. The JetStep X500 system features the industry’s largest exposure field , fine line RDL resolution with large depth of focus (DOF), excellent overlay accuracy, and automatic magnification compensation with independent x and y magnification adjustment. The JetStep X500 system handles a large range of substrate thicknesses with high levels of warp, offering unique imaging parameter control to compensate for panel distortion. Additionally, it can run highly warped substrates with an edge clamping option and provides real-time autofocus at every exposure site to compensate for challenging topography.
Applications
- AICS
- Fan-out panel level packaging (FOPLP)
- Large package formats, exposed without stitching
- Large interposers
- Redistribution layer (RDL) / underbump metallization (UBM)
- Vias in photo imageable dielectric (PID)
Featured Markets


Adaptive Shot Lithography Solution
Die shift on reconstituted panels can significantly impact both productivity and yield. To address this challenge, we use a parallel die placement measurement process and advanced analytics to provide a means to balance productivity against yield. Our integrated lithography cell, featuring Firefly inspection, StepFAST software, and JetStep Lithography, delivers industry-leading throughput and yield for fan-out panel level packaging.
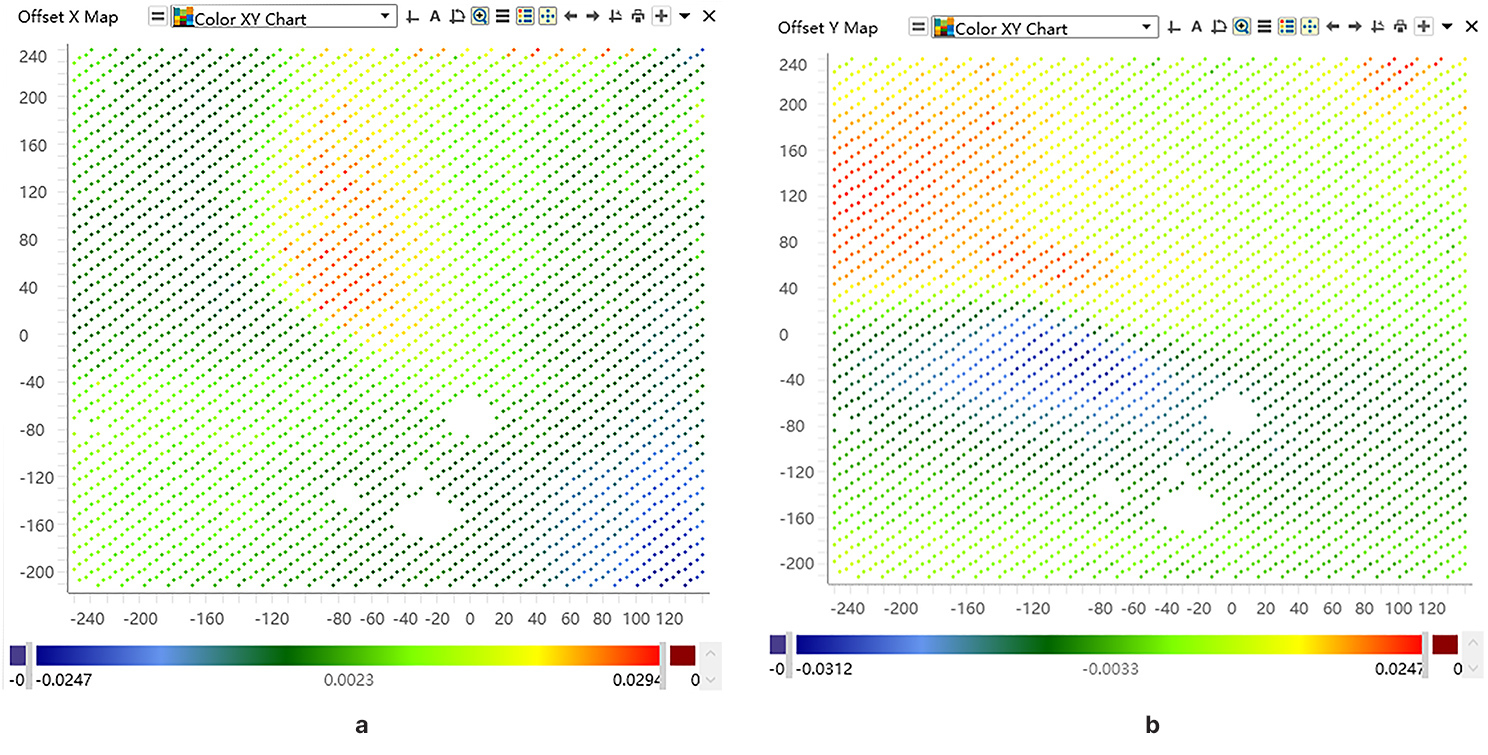
Overcoming FOPLP Die Placement Error
It is well understood that advanced packaging applications require high performance, low cost, increased functionality and improved reliability that 2.5D and 3D packaging solutions provide. Fan-out panel-level packaging (FOPLP) is one of the technologies that has the potential to meet these packaging requirements.
Adaptive Overlay Control
During the processing of organic (CCL) advanced IC substrates (AICS) the substrates become distorted which impacts the overlay of Via to RDL pad structures. To solve this problem, the stepper must adjust the alignment solution to match the previous layer’s distortion by measuring the overlay. Proprietary software provides the user with the ability to adjust each zone of the AICS with independent offsets.
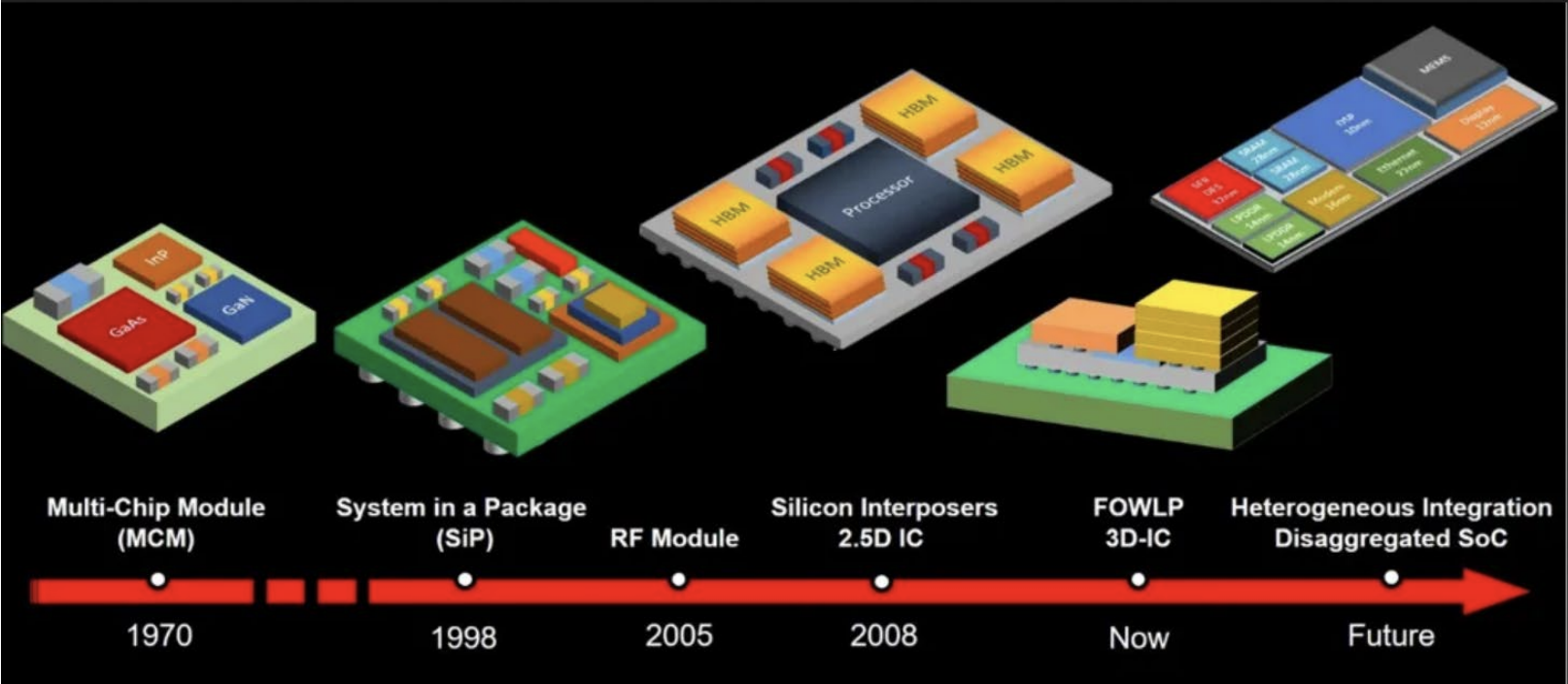
Analysis of Pattern Distortion by Panel Deformation
The growing demand for heterogeneous integration is driven by the 5G market. This includes smartphones, data centers, servers, high-performance computing (HPC), artificial intelligence (AI) and internet of things (IoT) applications. Next generation packaging technologies require tighter overlay to accommodate larger package sizes with fine-pitch chip interconnects on large-format flexible panels.

Do you have a JetStep X500 question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
JetStep® S3500 System
The JetStep S3500 system is designed to provide OSATS with a high-volume manufacturing advanced packaging lithography solution. For substrates up to 720mm x 600mm, it supports fan-out panel level packaging.

Product Overview
The JetStep S3500 panel lithography system is specifically designed for advanced packaging panel production. As fan-out packages increase in size and complexity, requiring panel substrates instead of wafers, the JetStep S3500 system addresses these challenges with advanced features. It handles die shift caused by placement accuracy errors, CTE mismatch and panel warpage. The system incorporates a large exposure field (59.4 x 59.4mm) with resolution capability to 2/2 L/S and options for increased resolution to 1/1. In addition, it supports multiple exposure wavelengths, ideal for process development with new photosensitive polymers. Application-specific options include warped panel handling, “on-the-fly” optical focus, and die shift correction (StepFAST™ Solution), helping to ensure precise and reliable panel-level packaging.
Applications
- Fan-out panel level packaging (FOPLP)
- Interposers
- Photo imageable Dielectric (PID) vias
- Redistribution lines (RDL) / Under bump metallization (UBM)
- Non-standard substrates
Featured Markets
Adaptive Shot Lithography Solution
Die shift on reconstituted panels can significantly impact both productivity and yield. To address this challenge, we use a parallel die placement measurement process and advanced analytics to provide a means to balance productivity against yield. Our integrated lithography cell, featuring Firefly inspection, StepFAST software, and JetStep Lithography, delivers industry-leading throughput and yield for fan-out panel level packaging.
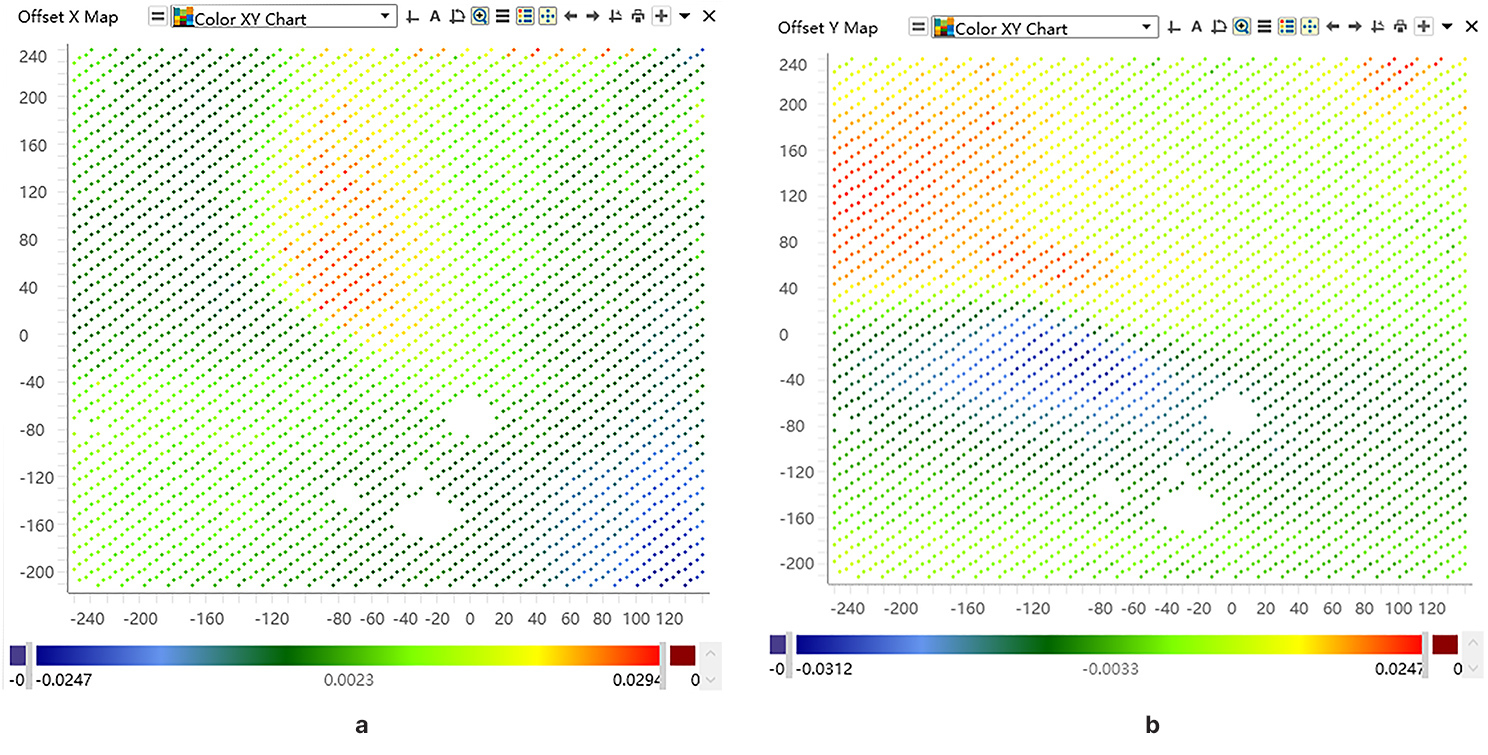
Overcoming FOPLP Die Placement Error
It is well understood that advanced packaging applications require high performance, low cost, increased functionality and improved reliability that 2.5D and 3D packaging solutions provide. Fan-out panel-level packaging (FOPLP) is one of the technologies that has the potential to meet these packaging requirements.

Do you have a JetStep S3500 question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
PrimaScan™ P System
The PrimaScan P System provides all-surface defect and contamination inspection with imaging capability for glass panel substrates.

Product Overview
As panel-level-packaging (PLP) transition from copper-clad laminates (CCL) to glass, the industry must adapt to ensure starting substrates are free of killer defects and contamination or latent defects that may result in yield loss or scrapped panels at later stages in the process flow. The PrimaScan P system is specifically designed to address incoming glass panel quality control for both the advanced IC substrate (AICS) and fan-out panel level processing (FOPLP) segments.
The PrimaScan P system delivers unique laser-based scanning and imaging via proprietary optics and sensing technologies for the reliable inspection of nanometer sized defects for either R&D or high-volume manufacturing environments. Utilizing multiple channel inspection technologies, the system can detect, measure and image surface particles, scratches, pits, surface contamination, stains, film or bulk panel stress, voids/inclusions, including chips and cracks at the edge of the panel.
Applications
- Incoming unpatterned glass panel quality inspection
- Blanket photoresist, dielectric or metallic coated panels
- Buried defects and voids in transparent and semi-transparent blanket films
- Across panel stress and induced point stress
Featured Markets

Do you have a PrimaScan P question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Firefly® G3 System
The Firefly G3 system provides automated inspection and 3D metrology for advanced IC substrates and panel level packaging, delivering high resolution and productivity for demanding applications like high-performance computing (HPC), artificial intelligence (AI), cloud computing and machine/deep learning.

Product Overview
The Firefly G3 platform offers multiple imaging modes, including Onto Innovation’s patented Clearfind® Technology, a technique to detect residue defects on metal and metal defects on organic layers. The combination of high sensitivity inspection, 2D/3D metrology and on tool color image capture capability in a single platform reduces capital investment requirements and provides a reliable pathway for panel-based process applications that require high I/O counts and multiple-chip integration.
Integration with Onto Innovation’s Discover® Defect and TrueADC® software quickly turns defect data into actionable process control, improves defect classification and reduces manual review. It enables our customers to develop, learn and analyze new processes reliably while significantly improving their product delivery time to market.
Applications
- Advanced IC Substrates (AICS): CCL and Glass
- Fan-out Panel Level Packaging (FOPLP)
- Interposers
- Embedded Die substrates/ Interposer
- 2.5D/3D integration
Featured Markets
Adaptive Shot Lithography Solution
Die shift on reconstituted panels can significantly impact both productivity and yield. To address this challenge, we use a parallel die placement measurement process and advanced analytics to provide a means to balance productivity against yield. Our integrated lithography cell, featuring Firefly inspection, StepFAST software, and JetStep Lithography, delivers industry-leading throughput and yield for fan-out panel level packaging.
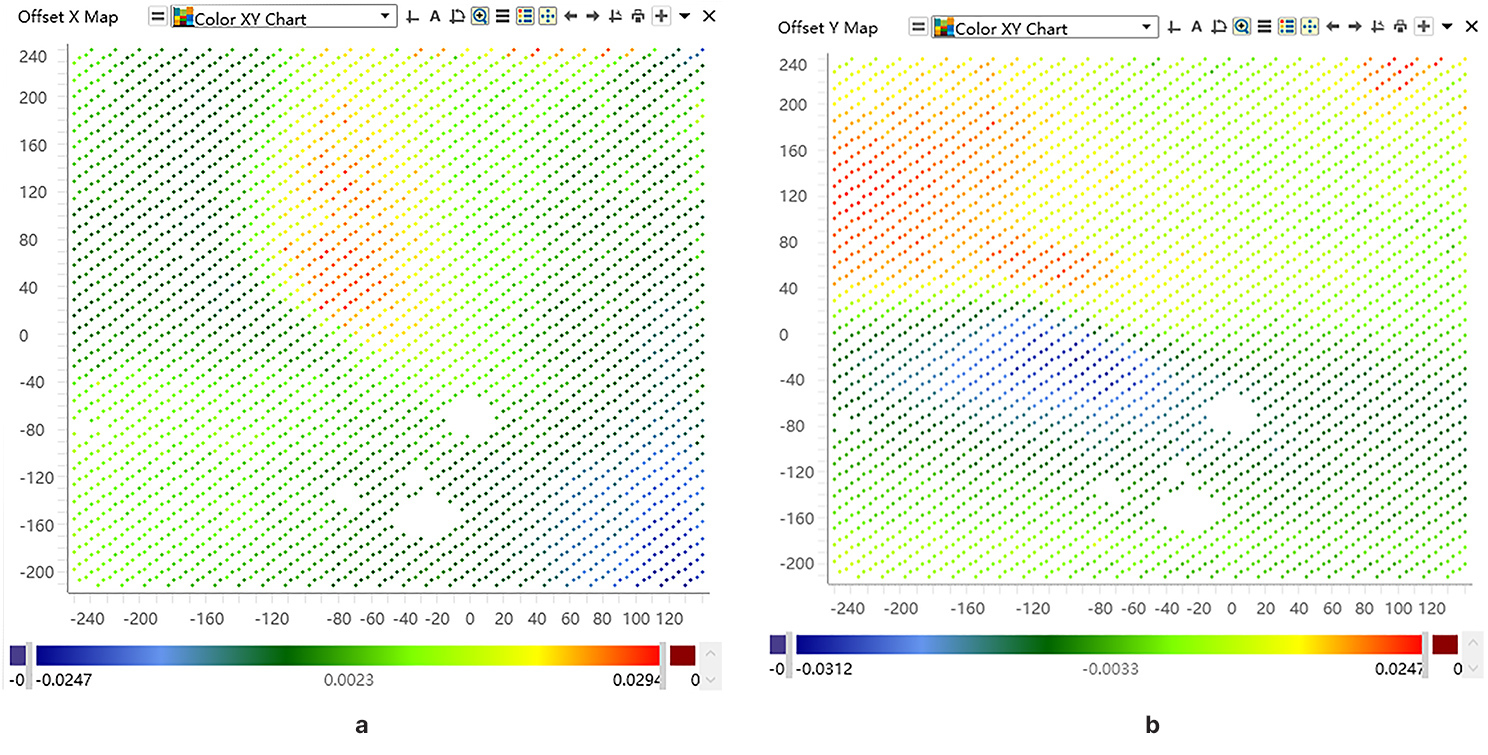
Overcoming FOPLP Die Placement Error
It is well understood that advanced packaging applications require high performance, low cost, increased functionality and improved reliability that 2.5D and 3D packaging solutions provide. Fan-out panel-level packaging (FOPLP) is one of the technologies that has the potential to meet these packaging requirements.
Adaptive Overlay Control
During the processing of organic (CCL) advanced IC substrates (AICS) the substrates become distorted which impacts the overlay of Via to RDL pad structures. To solve this problem, the stepper must adjust the alignment solution to match the previous layer’s distortion by measuring the overlay. Proprietary software provides the user with the ability to adjust each zone of the AICS with independent offsets.
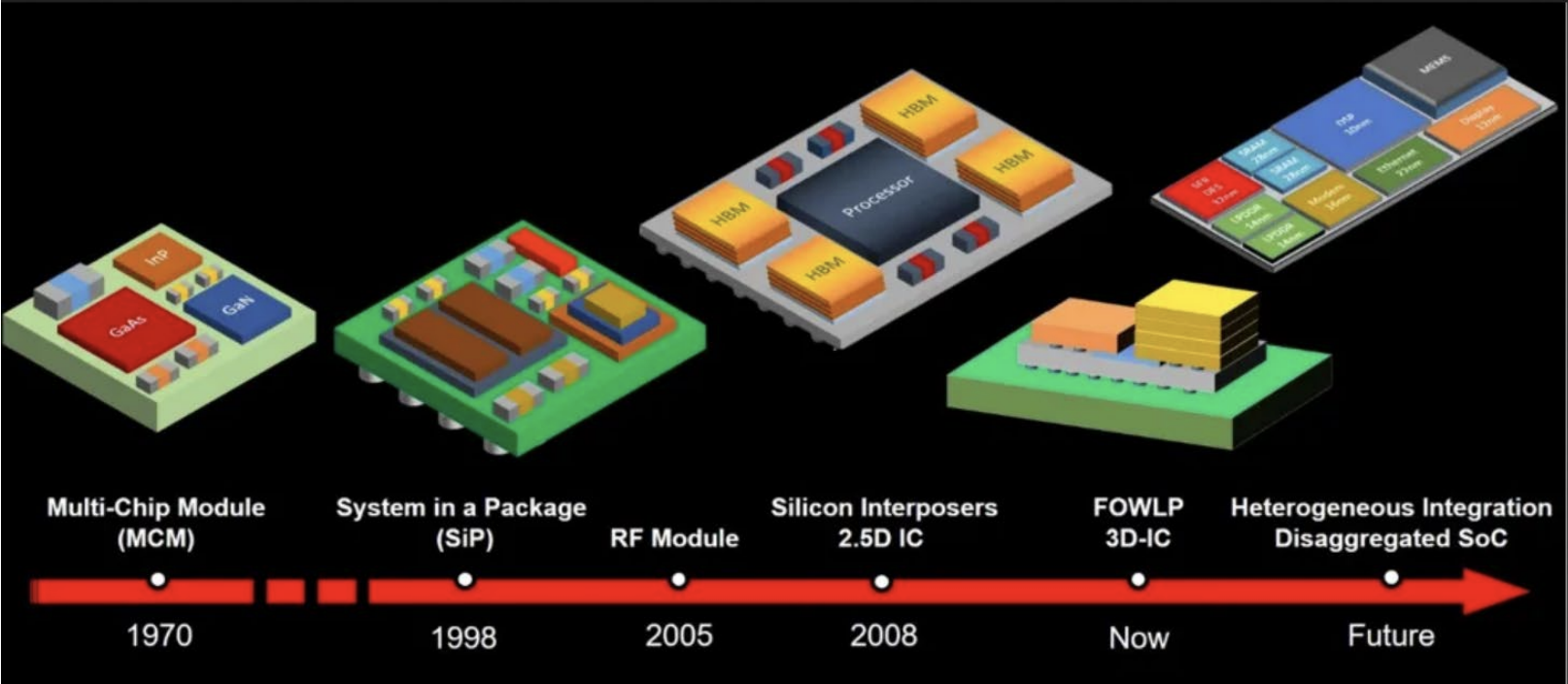
Analysis of Pattern Distortion by Panel Deformation
The growing demand for heterogeneous integration is driven by the 5G market. This includes smartphones, data centers, servers, high-performance computing (HPC), artificial intelligence (AI) and internet of things (IoT) applications. Next generation packaging technologies require tighter overlay to accommodate larger package sizes with fine-pitch chip interconnects on large-format flexible panels.

Do you have a Firefly G3 system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields