
Atlas® G6 System
The Atlas G6 system is an OCD and thin film metrology tool engineered for the most advanced logic and memory devices. Designed to meet the demands of next-generation AI applications and beyond, it delivers enhanced optics, AI-driven recipe development, and tighter tool matching for superior process control.

Product Overview
As semiconductor manufacturers push into next-generation GAA nodes and next-gen HBM and vertical DRAM architectures, process control requirements are tightening. Smaller nanosheet structures and denser DRAM cells demand higher measurement precision, faster recipe development, and tighter tool-to-tool matching.
The Atlas® G6 system is engineered to meet these challenges with a new optics design that improves signal-to-noise ratio, spectral stability, and measurement precision. Enhanced software algorithms and data management tools deliver better fleet-wide spectra matching, while a new data channel and next-generation model-guided machine learning in Ai Diffract™ software enable faster, more robust recipe development. A smaller optical spot size ensures accurate measurements on today’s most compact DRAM structures.
Fully integrated with Onto Innovation’s Discover® ecosystem, the Atlas G6 system empowers fabs with predictive process control and smart manufacturing capabilities—accelerating yield and time to market for the industry’s most advanced devices.
Applications
- OCD for litho, etch, CVD & CMP process in all device segments
- Local variation
- Asymmetry and tilt
- Common and critical films
- Stress & wafer warpage

Do you have an Atlas G6 system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Inspection Tool Productivity Software
The native integration of the Discover software platform boosts tool throughput and enhances inspection quality by capturing more defects of interest. It provides a complete reduced review solution utilizing advanced machine learning (ML) and artificial intelligence (AI) technologies, customized to meet unique customer needs.
Enhance Your Inspection & Metrology Experience with Onto Software
Optimized Image Capture for Inspection Tools
Discover software enhances inspection quality and tool throughput by optimizing the image capture sample plan.
AI-Powered Automatic Defect Classification (TrueADC Software)
Integrated AI-based classification improves device quality and yield, driving fab efficiency and productivity.
Streamlined Review Software
Reduced review best practices improve operator productivity, enhance engineering review quality, and shorten review time.
Advanced Defect Analytics
Comprehensive inline wafer/panel monitoring enables automatic alarm notifications, detailed reports and Out-of-Control Action Plans (OCAPs).
Defect Source Analysis
Enables actionable process feedback to improve manufacturing outcomes.
Automated Business Analysis with Report Server
Boosts engineering productivity by up to 25% and supports multiple production report formats.
Machine Learning-Based Pattern Detection
The Discover Patterns software module proactively identifies wafer-level systematic yield-limiting issues and classifies them for analytics, enabling both process feedback and feedforward.
Centralized Defect & Metrology Management
Built on a scalable Big Data and high-availability architecture, this solution supports advanced applications such as high volume manufacturing (HVM) bump metrology, capable of handling wafers with over 100 million bumps.
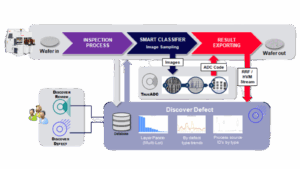

Do you have an Inspection Tool Productivity Software question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
OCD Solutions
A suite of OCD modeling software and computing hardware that enables the full capability and connectivity across all Onto OCD and thin film metrology systems, including Atlas, Aspect, Iris and IMPULSE systems.

Product Overview
Onto Innovation’s OCD technology offers powerful modeling and computing packages to support various phases of film and OCD measurement setup, data management, and fleet management. These capabilities include model building, runtime data analysis, system calibration, data analytics, data connectivity and management, spectrum management and fleet matching.
Onto OCD solutions consist of several modeling and computing components, including Ai Diffract™ modeling software, runtime onboard computer, offline modeler, offline model building clusters, and recipe & data management server. Each component seamlessly extends OCD capabilities to Onto’s standalone and integrated metrology systems, providing end-to-end capabilities from offline recipe support and development to fab-wide networking and connectivity for easy fleet management.
Learn more about each component below.
Featured Markets
Ai Diffract™ Software
AI-guided OCD modeling and analysis software for high accuracy in-line optical metrology and offline recipe development
Ai Diffract software is a powerful modeling, visualization and analysis software with an intuitive 3D modeling interface to simplify the building and visualization of today’s most complex semiconductor devices. It offers OCD modeling and advanced machine learning capabilities, next-generation real-time regression, offline sensitivity analysis tools and comprehensive GUI and structure input for true multi-variant modeling. Ai Diffract software’s proprietary fitting algorithms enable fast and accurate calculations for signal processing, helping ensure high fidelity model-based measurements. Automation features for spectral fitting, recipe optimization, and sensitivity analysis offer great user productivity. The first-in-market AI-guided engine synergizes physics-based modeling and machine learning to deliver the most robust solution with quick time to solution.
Ai Diffract Modeler is the offline analytical engine that allows users to create and edit recipes offline. It supports multiple users and can connect to Ai Diffract cluster for high intensity computing.
Ai Diffract Onboard is the on-tool runtime engine that maximizes tool throughput for complex use cases. It ensures rapid analysis without interfering with system operation or impacting throughput.
Ai Diffract Cluster is an enterprise scale computing server deployed for offline recipe development or in-line real-time regression. Optimized to support the workload of Ai Diffract software analysis, it scales based on fleet size, recipe numbers, and computing intensity.
Recipe Distribution Server (RDS) / Nexus Servers is a fab-wide networking and server system for fleet management and connectivity. RDS/Nexus servers provide connectivity and support to Ai Diffract recipe management and distribution, data/spectrum feed-forward and feedback, spectrum management, and fleet management.

Do you have an OCD solutions question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Atlas® III+ System
The Atlas III+ system provides dependable OCD and thin film metrology for established technologies, with flexible performance across a wide range of process layers and device types.

Product Overview
The Atlas III+ system is a widely adopted inline OCD metrology system, known for its robust and reliable solutions across all OCD and film layers from FEOL to BEOL. With its information-rich optical architecture, powerful OCD and machine learning analysis engine, the Atlas III+ system excels in advanced logic, 3D NAND and DRAM device processes. Extending metrology performance to sub-angstrom precision and accuracy levels, this system enables advanced process control across a broad range of applications in high volume manufacturing. The Atlas III+ system incorporates a proprietary spectroscopic reflectometry and spectroscopic ellipsometry solution, and when combined with Onto Innovation’s Ai Diffract™ OCD analysis software, it enables process control of every critical manufacturing unit operation. Users can gain insights into complex structure profiles across etch, clean, deposition and CMP steps.
Applications
- 3D-NAND
- DRAM: Logic and Foundry
- Specialty: CIS, AR/VR, Power & RF etc.
Intelligent Line Monitoring & Control with Integrated Metrology
Enhance CMP process control with a connected metrology approach that feeds forward data from standalone OCD or films metrology to integrated metrology, connected through AI-driven analytical software. This approach, powered by advanced modeling and analysis tools, can deliver high-precision, high-throughput results—minimizing or eliminating the need for and cost of new TEM data and enabling accelerated time to solution, faster excursion detection, reduced cost and improved Cpk.

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
As semiconductor manufacturers push the boundaries of performance and functionality—driven by high-performance computing and AI applications—chemical mechanical planarization (CMP) processes increase in intensity complexity. New logic transistor designs, 3D NAND stacking, and DRAM integration introduce more CMP layers and tighter process windows.

Do you have an Atlas III+ system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Atlas® V System
The Atlas V system is an OCD and thin film metrology tool for high volume manufacturing, enabling FinFET & Gate-All-Around (GAA) logic, DRAM, and 3D NAND device process control.

Product Overview
The Atlas V system combines state of the art optical design with an innovative Ai Diffract™ modeling engine, providing OCD and thin film metrology solutions for measuring complex 3D device structures. The dual channel optical architecture consists of a DUV 4×4 Mueller Matrix (MM) SE and a DUV polarized normal incident reflectometer (NIOCD). Together, they provide rich information for OCD analysis at high precision and high throughput. The Atlas V system is designed to measure the most critical and challenging process steps that include buried features, not visible by CD-SEM and other techniques.
With unique capabilities, such as measuring individual nanowire dimension in a GAA logic device, the Atlas V system is an enabling technology for leading edge device process control.
Applications
- OCD for litho, etch, CVD & CMP process in all device segments
- Local variation
- Asymmetry and tilt
- Common and critical films
- Stress & wafer warpage
Intelligent Line Monitoring & Control with Integrated Metrology
Enhance CMP process control with a connected metrology approach that feeds forward data from standalone OCD or films metrology to integrated metrology, connected through AI-driven analytical software. This approach, powered by advanced modeling and analysis tools, can deliver high-precision, high-throughput results—minimizing or eliminating the need for and cost of new TEM data and enabling accelerated time to solution, faster excursion detection, reduced cost and improved Cpk.

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
As semiconductor manufacturers push the boundaries of performance and functionality—driven by high-performance computing and AI applications—chemical mechanical planarization (CMP) processes increase in intensity complexity. New logic transistor designs, 3D NAND stacking, and DRAM integration introduce more CMP layers and tighter process windows.

Do you have an Atlas V system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields