
Metrology
Advanced optical critical dimension (OCD) and film metrology products to help ensure accuracy and repeatability for semiconductor manufacturers worldwide
As semiconductor chips become increasingly complex, the demand for precision dimensional and films metrology intensifies.
Traditionally vital for semiconductor logic and memory markets, advanced metrology is seeing expanded adoption in next-generation advanced packaging technologies and specialty applications as these segments continue to grow in value and become increasingly sophisticated.
Our comprehensive metrology solutions include OCD, films, overlay and composition metrology. These tools are crucial for detecting process excursions in high volume manufacturing and are instrumental in R&D for helping to develop the newest devices. We offer integrated and inline metrology solutions, powered by Onto Innovation’s AI-guided modeling and analysis software, to ensure high accuracy in-line optical metrology and efficient offline recipe development.


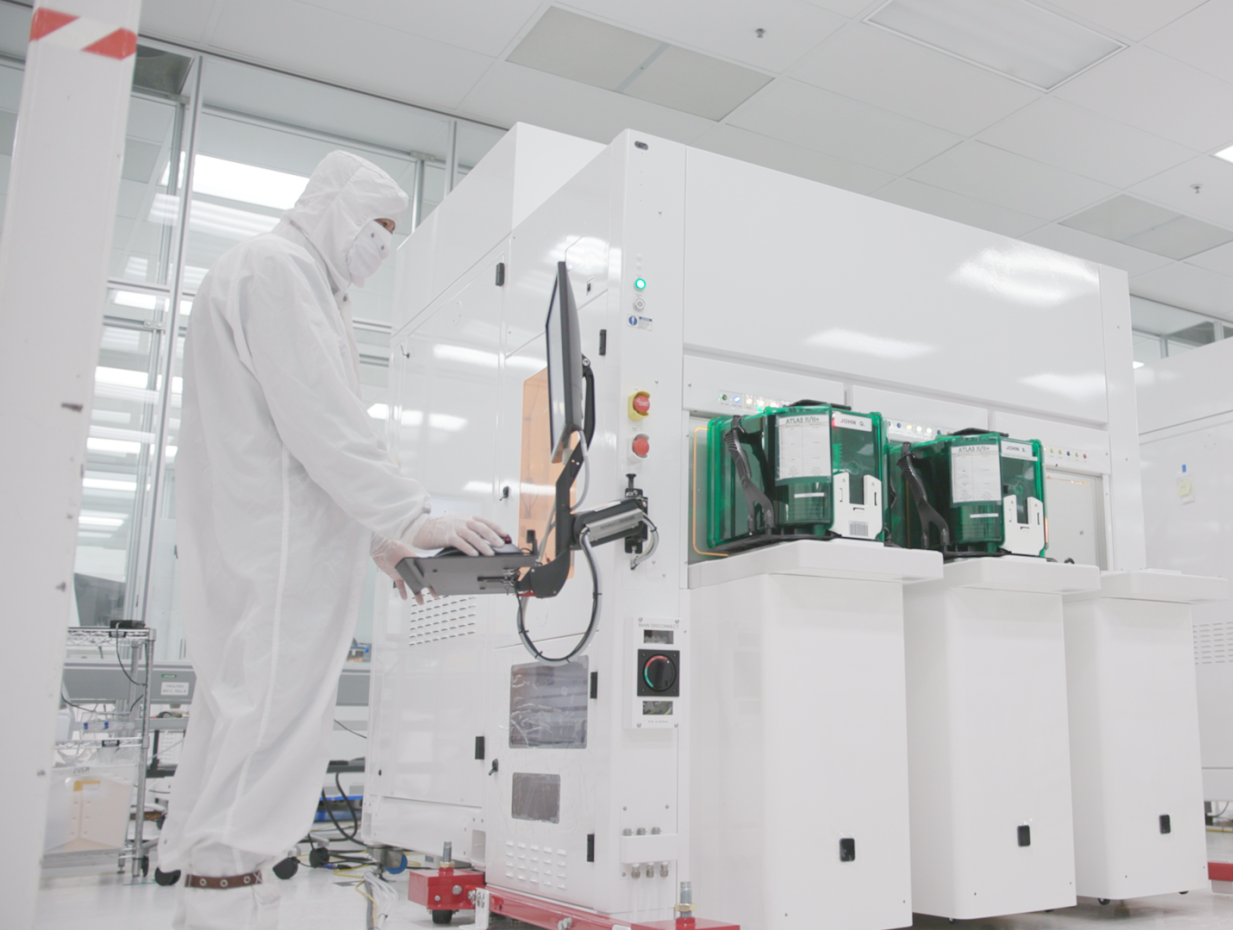


Iris™ G2 System

IMPULSE® V System

IVS 380 System

Atlas® V System

Echo™ System

Element™ G2 System

Aspect® System

Iris™ S System

Element™ S System

IVS 280 System

OCD Solutions

IMPULSE®+ System

Atlas® III+ System

FAaST® CV/IV System

FAaST® Digital SPV System

CnCV® System

Aspect S System

The Specialty Device Surge Part 1: Wafer Size Transitions Are Powering the Future of Specialty Devices and Bringing New Challenges
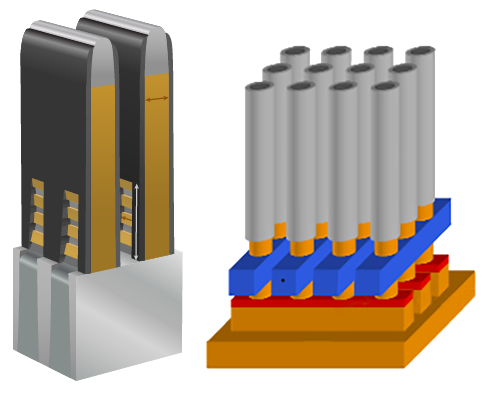
Smaller Geometries, Bigger Demands: The Role of OCD in GAA Logic and Vertical Gate DRAM Process Control

Through the Glass: Why the Rapid Development of TGV Demands Rigorous Analysis

Interconnect Innovations in High Bandwidth Memory, Part 1

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
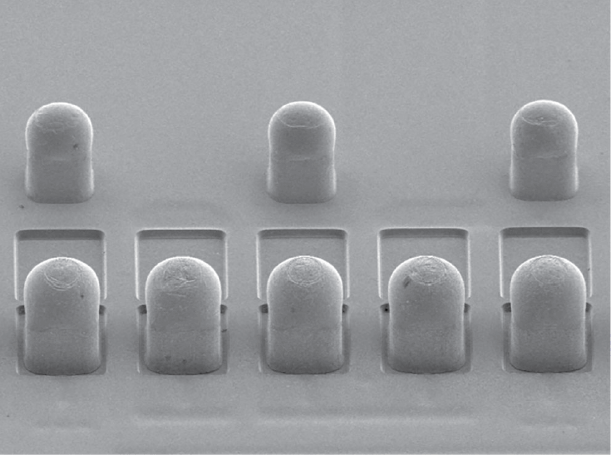
Bridging Performance and Yield: The Evolving Role of Interconnect Technologies in HBM
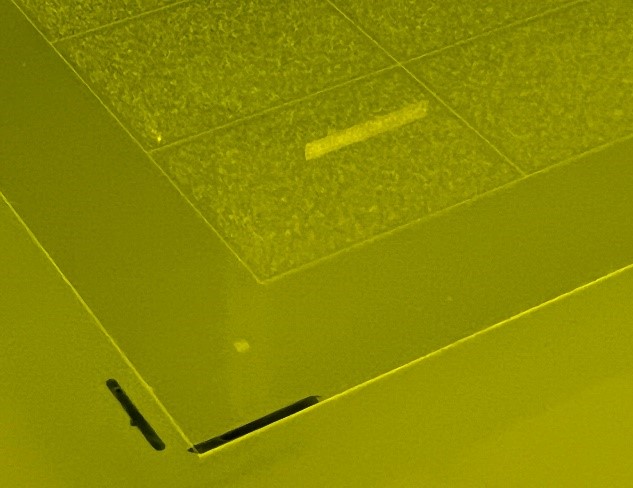
Comprehensive Process Control Solutions for Through Glass Vias

Enabling In-Line Process Control for Hybrid Bonding Applications

Using Picosecond Ultrasonic Technology for AI Packages, Part 2

Front-End Technologies Are The New Back-End Tools: Using Picosecond Ultrasonics Technology For AI Packages, Part 1
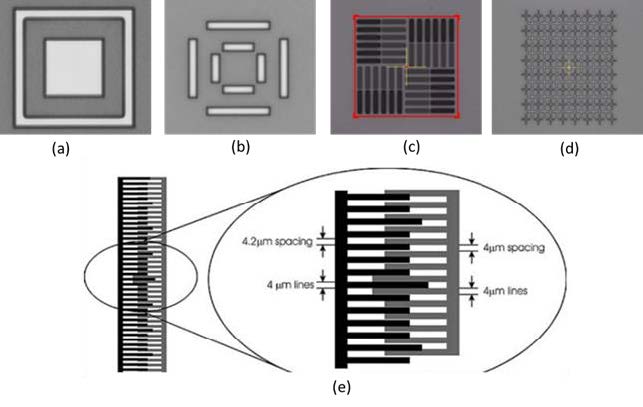
CD Step Application in Edge Air Layer Structure Measurement for Bulk Acoustic Resonator
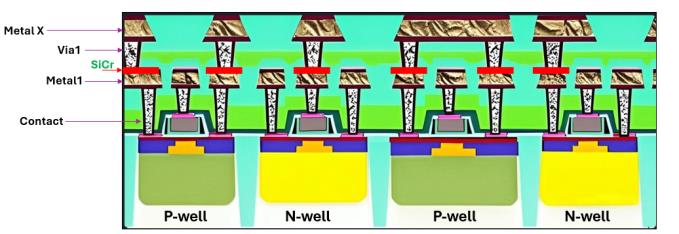
Picosecond Ultrasonics: An Advanced Technology Utilized for Process Control of SiCr Thin Film Resistors
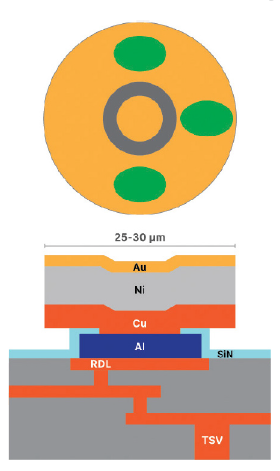
Advanced Interconnect Process Control with Picosecond Ultrasonic Technology for AI Device Packaging

Applications of Picosecond Laser Acoustics for Advanced Packaging
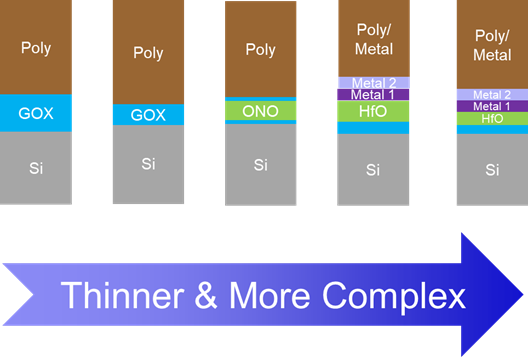
Measuring Multi-Layer Ultra-Thin Critical Films
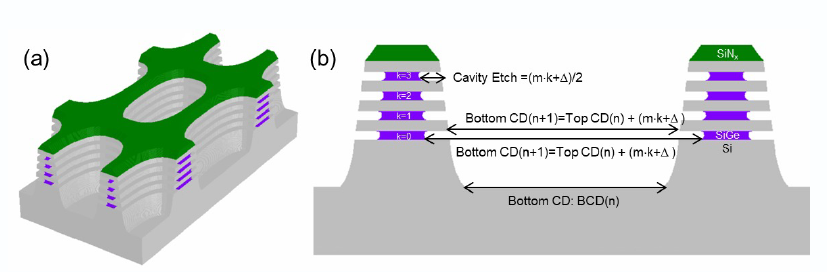
Optical Critical Dimension Metrology with Spectroscopic Ellipsometry

Addressing The Challenges of Metrology for Advanced Packaging
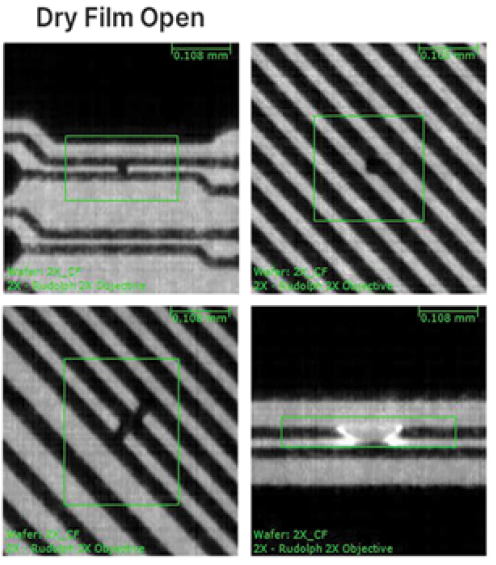
Using 2D/3D Technology to Overcome Challenges of Large-Area Panel Inspection and Metrology

Using Picosecond Ultrasonics To Measure Trench Structures In SiC Power Devices

Non-destructive Measurement of Bottom Width in Deep Trench Isolation Structures Using IRCD Metrology

Non-destructive Metrology Techniques for Measuring Hole Profile in DRAM Storage Node

Advanced FTIR Optical Modeling for Hydrogen Content Measurements in 3D NAND Cell Nitride and Amorphous Carbon Hard Mask

Using OCD To Measure Trench Structures in SiC Power Devices
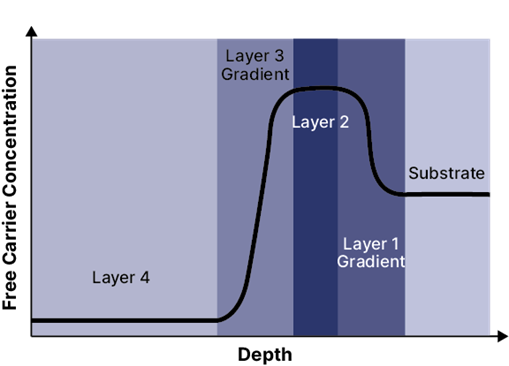
Using FTIR To Improve SiC Power Device Performance

Changing Shop Floor Metrology From a Cost to a Benefit

The Road to SiC Process Control
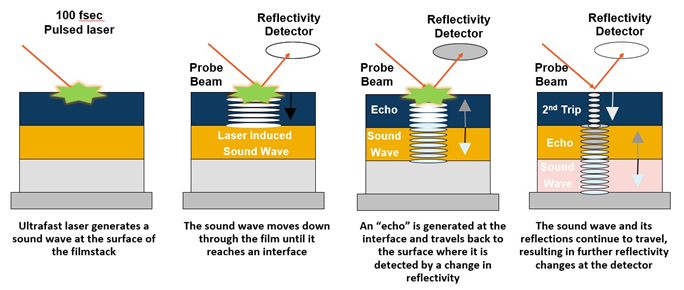
Optimizing Metal Film Measurement on IGBT And MOSFET Power Devices with Picosecond Ultrasonic Technology

3D NAND Needs 3D Metrology

Measuring the Critical W-recess in 3D NAND

The Age of Hybrid Bonding: Where We Are and Where We’re Going

A Star is Born: Gallium nitride and the coming age of compound semiconductors

Efficient pump-probe sampling with a single-cavity dual-comb laser: Application in ultrafast photoacoustics

Metrology Sampling Plans Are Key For Device Analytics And Traceability

Paving the Way for 5G: RF Filter Process Monitoring and Control Using Picosecond Ultrasonic Metrology
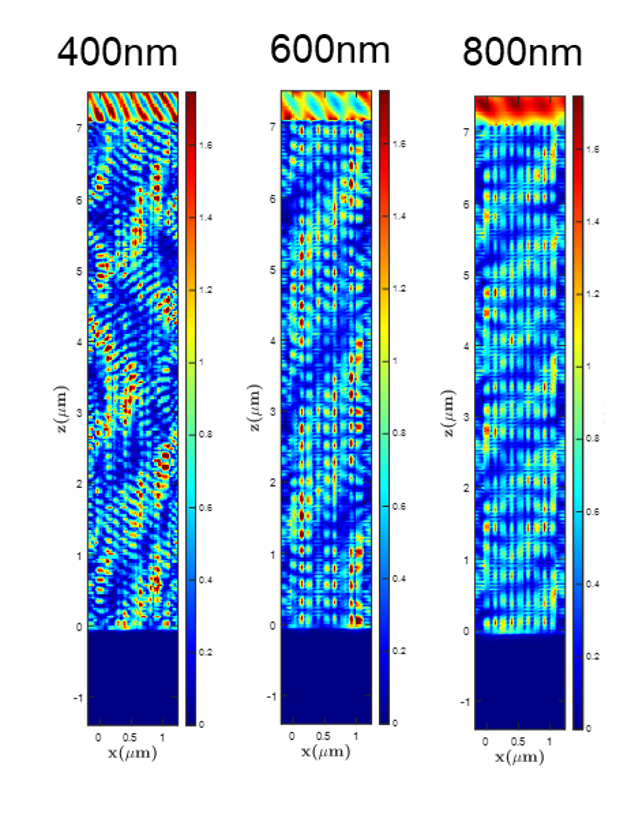
Critical Moves: Advanced Logic Devices And CIS Benefit From Applications Using IRCD Metrology

Advanced Modeling In FTIR Offers New Applications For HVM

Optical Critical Dimension Metrology for Semiconductor Manufacturing

Reducing Rework In CMP: An Enhanced Machine Learning-Based Hybrid Metrology Approach
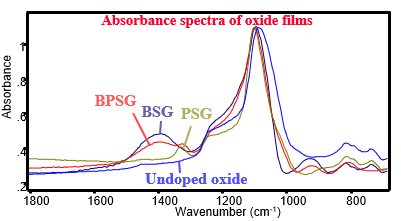
Expanded Material Metrology For Refined Etch Selectivities
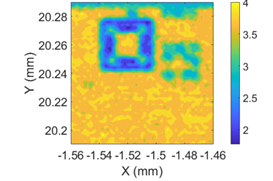
Imaging of Overlay and Alignment Markers Under Opaque Layers Using Picosecond Laser Acoustic Measurements

Mid-Infrared Optical Metrology for High Aspect Ratio Holes in 3D NAND Memory Manufacturing

Advantages of Picosecond Ultrasonic Technology for Advanced RF Metrology

Untangling 3D NAND: Tilt, Registration, and Misalignment

Metrology Solutions for Gate-All-Around Transistors in High Volume Manufacturing

Monitoring Critical Process Steps in 3D NAND using Picosecond Ultrasonic Metrology with both Thickness and Sound Velocity Capabilities

Full Metrology Solutions for Advanced RF with Picosecond Ultrasonic Metrology

Artificial Intelligence and Machine Learning in Semiconductor Manufacturing: Inspection and Metrology

Do you have a metrology question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
