
CnCV® System
The CnCV system enables wafer-level characterization of WBG materials without test device fabrication, reducing time and cost. As a mercury-free alternative to MCV, it eliminates contamination concerns. The enhanced Kinetic CV mode with UV-assisted corona charge neutralization achieves high throughput and precision for fast, reliable process control.

Product Overview
The CnCV system utilizes a novel constant surface potential corona charging, which enables the precision required over a large voltage range. The patented technology includes charge- and photo-assisted modes, especially suited for speed and precision on WBG materials and structures, including SiC, Ga2O3, GaN, and AlGaN/GaN HEMT. Additionally, Corona-Kelvin characterization includes electrical properties of dielectrics and interfaces of films on SiC and GaN epi layers. An automated top-side edge contact (TSEC) is also available enabling characterization of WBG on insulating/semi-insulating substrates. Automated bias-temperature stress (BTS) measurements are also available with the CnCV system, providing a fast, noncontact way to quantify the reliability of passivated SiC and GaN.
Beyond typical CV type parameters, the full wafer corona approach allows for QUAD (quality, uniformity, and defect) mapping. The electrical defect imaging, QUAD-EDI, mode is especially designed for SiC. It provides a unique means for quick screening of epi electrical defectivity enabling improvement in device yield prediction.

Figure 1. QUAD-EDI Map on final metallized device wafer after Merged Schottky PiN diode fabrication identifying failed dies.
Applications
- Non-contact epi dopant depth profiling in WBG materials
- AlGaN\GaN HEMT measurements (pinch off voltage & 2DEG sheet charge)
- Dielectric and interface characterization electrical defect imaging in SiC for yield prediction
- Bias-temperature stress (BTS) instability measurements on passivated WBG materials
Featured Markets

Do you have a CnCV system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
PrimaScan™ System
The PrimaScan wafer defect inspection system delivers a flexible, high sensitivity solution at the lowest cost of ownership per pass.
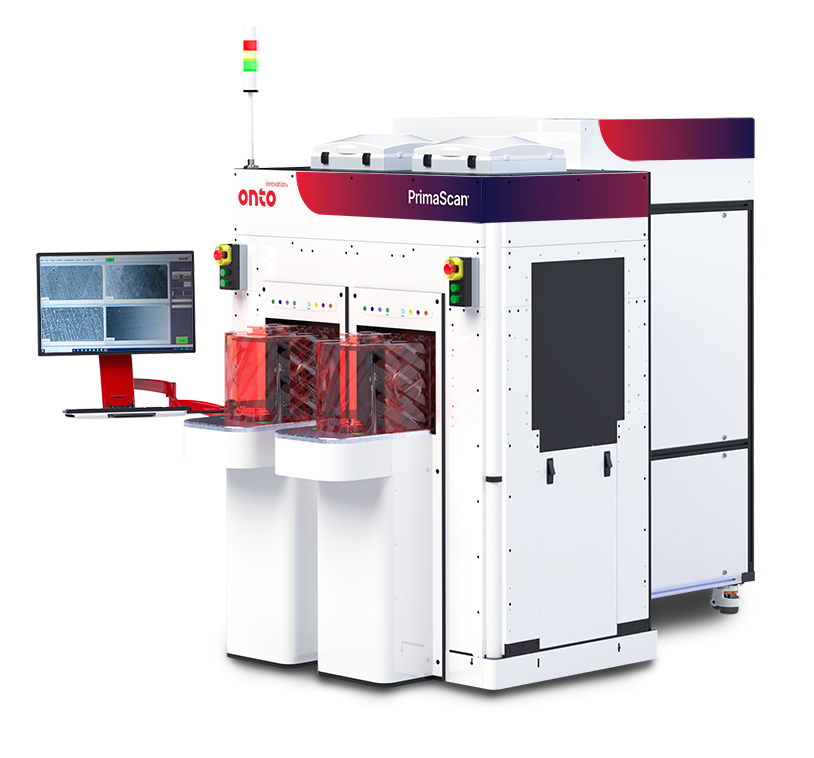
Product Overview
The PrimaScan system utilizes laser scatterometry and imaging techniques leveraging proprietary optics and sensing technologies for reliable inspection of nanometer sized defects on a variety of opaque and transparent/semi-transparent substrates suitable for either R&D or high-volume manufacturing environments. With multiple detection channels, the system can detect, measure, characterize and image surface particles, scratches, pits, bumps, surface contamination, film or bulk wafer stress, voids/inclusions, including chips and cracks at the wafer edge.
The PrimaScan system addresses challenges in both incoming wafer quality control and in inline process monitoring. Capable of handling multiple substrate materials, it uniquely addresses inline process defect and contamination monitoring in wafer-based production environments.
Designed with versatility in mind the PrimaScan system can handle a variety of wafer sizes and substrate types
Applications
- Opaque or transparent wafer incoming quality (ICQ) inspection
- Process monitor wafer particle and contamination inspection
- Unpatterned blanket photoresist, dielectric or metallic coated wafer defect inspection
- Subsurface defectivity inspection for transparent and semi-transparent films and substrates
- Glass carrier wafer defect and contamination inspection for advanced packaging
- Glass wafer defect and contamination inspection for microfluidics, microlens arrays for AR/VR/MR, flat optics, etc.

Do you have a PrimaScan system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
NSX® 330 System
The NSX 330 system offers advanced macro inspection for a wide range of defect sizes at high throughput, with optional 3D metrology integration.

Product Overview
The NSX 330 system features robust platform technology with high-acceleration staging, high-speed multi-processor computing and flexible software. With over 1,000 installation worldwide, the NSX 330 System offers 2D inspection and metrology at high throughput and a broad portfolio of 3D sensors supporting critical advanced packaging applications. These include wafer-level metrology for micro bumps, RDL, kerf, overlay, and through silicon via (TSV) in a single wafer load.
Accommodating wafers from 100mm to 330mm, the system features a versatile objective turret, programmable light tower, and multiple dark field illumination modes. Additional features include resolution flexibility, unique handling solutions, and comprehensive software for recipe sharing and offline analysis. The NSX 330 system, with optional edge and backside inspection via the EB40 module, provides a comprehensive all-surface inspection solution packaging technology challenges.
Applications
- Macro inspection: whole wafer, and film frame
- Gel and waffle pack inspection
- OQA and post saw
- Post Probe and Testing
- Substrate thickness, TTV, and bonded wafer thickness stack thickness (carrier, adhesive, product wafer and total stack)
- Via depth thick and thin RST
- Bow and warp
Featured Markets

Do you have an NSX 330 system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
F30™ System
The F30 system is designed to blur the lines between dark field micro inspection and traditional macro inspection, providing automated defect inspection for front-end and outgoing quality (OQA) applications.

Product Overview
The F30 automated defect inspection system combines high resolution and throughput to drive fab yield and productivity. A five-objective turret enables resolution-throughput flexibility, while its multi-channel illumination including brightfield, darkfield, high-angle ring light, and IR-Review addresses the requirements for today’s multi-process inspection applications. Equipped with an advanced productivity suite (waferless recipe creation, simultaneous FOUP, recipe server and tool matching), the F30 System redefines inspection cost of ownership expectations. The system can handle 100mm – 300mm wafers can be paired with the edge and backside module (EB40) to provide an all-surface inspection solution.
Applications
- After develop inspection (ADI)
- Post CMP inspection
- After etch inspection
- Fab Outgoing QA
Featured Markets

Do you have a F30 system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Celero™ PL System
The Celero PL system is designed for subsurface defect inspection and classification for silicon carbide (SiC) and gallium nitride (GaN) based wafers and compound semiconductor materials.

Product Overview
The Celero PL system utilizes a laser-based phase detection and imaging capability that leverages custom optics and image processing algorithms to enable best in class throughput and sensitivity for silicon carbide and gallium nitride-based materials on 100mm to 300mm wafer sizes. Leveraging multiple light sources and sensor channels, the system can detect, measure and image a broad variety of subsurface crystalline defects, associated with bulk wafers and epitaxial layers, surface particles, scratches, pits, surface contamination, stains, point or bulk wafer stress, voids/inclusions, including chips and cracks at the edge of the wafer.
Applications
- Frontside / backside / edge / subsurface defectivity and contamination
- Crystalline defectivity in III-V substrates and epitaxial layers
- Thick wafer / seed wafer surface and sub-surface defectivity
- Substrate-to-epitaxial layer defect mapping (sub-defect mapping)
- Wafer based microLED / VCSEL / EE laser materials
Featured Markets

Do you have a Celero PL system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
PrimaScan™ R&D System
The PrimaScan R&D System is a stand-alone, manual load version of the PrimaScan automated wafer defect and contamination inspection system that has been specifically designed with R&D and lab environments in mind.

Product Overview
The PrimaScan R&D system offers a smaller spot size and higher pixel resolution than its high volume production counterpart tools. The flexibility in sample handling options combined with the multiple sensing channels and higher resolution imaging makes this the ideal tool for R&D and lab environments. Similar to the other tools in the PrimaScan line, the PrimaScan R&D system offers reliable inspection of nanometer sized defects on a variety of opaque and transparent/semi-transparent substrates and samples suitable for either R&D or lab environments. The system can detect, measure, characterize and image surface particles, scratches, pits, bumps, surface contamination, film or bulk wafer stress, voids/inclusions, including chips and cracks at the wafer edge.
Designed with versatility in mind the PrimaScan R&D system can handle a variety of wafer sizes and substrate types including film frame, photomask and sample tray.
Applications
- Opaque or transparent wafer incoming quality (ICQ) inspection
- Process monitor wafer particle and contamination inspection
- Unpatterned blanket photoresist, dielectric or metallic coated wafer defect inspection
- Subsurface defectivity inspection for transparent and semi-transparent films and substrates
- Glass wafer defect and contamination inspection for microfluidics, microlens arrays for AR/VR/MR, flat optics, etc.
- Post-CMP or post-grind defect inspection

Do you have a PrimaScan R&D question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields











