
OCD Solutions
A suite of OCD modeling software and computing hardware that enables the full capability and connectivity across all Onto OCD and thin film metrology systems, including Atlas, Aspect, Iris and IMPULSE systems.

Product Overview
Onto Innovation’s OCD technology offers powerful modeling and computing packages to support various phases of film and OCD measurement setup, data management, and fleet management. These capabilities include model building, runtime data analysis, system calibration, data analytics, data connectivity and management, spectrum management and fleet matching.
Onto OCD solutions consist of several modeling and computing components, including Ai Diffract™ modeling software, runtime onboard computer, offline modeler, offline model building clusters, and recipe & data management server. Each component seamlessly extends OCD capabilities to Onto’s standalone and integrated metrology systems, providing end-to-end capabilities from offline recipe support and development to fab-wide networking and connectivity for easy fleet management.
Learn more about each component below.
Featured Markets
Ai Diffract™ Software
AI-guided OCD modeling and analysis software for high accuracy in-line optical metrology and offline recipe development
Ai Diffract software is a powerful modeling, visualization and analysis software with an intuitive 3D modeling interface to simplify the building and visualization of today’s most complex semiconductor devices. It offers OCD modeling and advanced machine learning capabilities, next-generation real-time regression, offline sensitivity analysis tools and comprehensive GUI and structure input for true multi-variant modeling. Ai Diffract software’s proprietary fitting algorithms enable fast and accurate calculations for signal processing, helping ensure high fidelity model-based measurements. Automation features for spectral fitting, recipe optimization, and sensitivity analysis offer great user productivity. The first-in-market AI-guided engine synergizes physics-based modeling and machine learning to deliver the most robust solution with quick time to solution.
Ai Diffract Modeler is the offline analytical engine that allows users to create and edit recipes offline. It supports multiple users and can connect to Ai Diffract cluster for high intensity computing.
Ai Diffract Onboard is the on-tool runtime engine that maximizes tool throughput for complex use cases. It ensures rapid analysis without interfering with system operation or impacting throughput.
Ai Diffract Cluster is an enterprise scale computing server deployed for offline recipe development or in-line real-time regression. Optimized to support the workload of Ai Diffract software analysis, it scales based on fleet size, recipe numbers, and computing intensity.
Recipe Distribution Server (RDS) / Nexus Servers is a fab-wide networking and server system for fleet management and connectivity. RDS/Nexus servers provide connectivity and support to Ai Diffract recipe management and distribution, data/spectrum feed-forward and feedback, spectrum management, and fleet management.

Do you have an OCD solutions question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
PrimaScan™ System
The PrimaScan wafer defect inspection system delivers a flexible, high sensitivity solution at the lowest cost of ownership per pass.
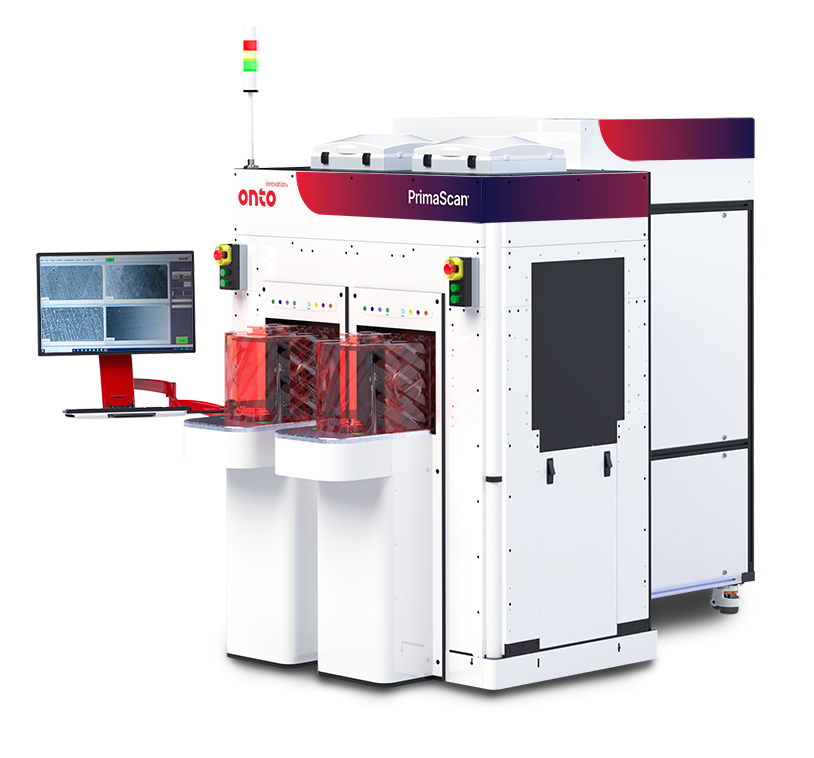
Product Overview
The PrimaScan system utilizes laser scatterometry and imaging techniques leveraging proprietary optics and sensing technologies for reliable inspection of nanometer sized defects on a variety of opaque and transparent/semi-transparent substrates suitable for either R&D or high-volume manufacturing environments. With multiple detection channels, the system can detect, measure, characterize and image surface particles, scratches, pits, bumps, surface contamination, film or bulk wafer stress, voids/inclusions, including chips and cracks at the wafer edge.
The PrimaScan system addresses challenges in both incoming wafer quality control and in inline process monitoring. Capable of handling multiple substrate materials, it uniquely addresses inline process defect and contamination monitoring in wafer-based production environments.
Designed with versatility in mind the PrimaScan system can handle a variety of wafer sizes and substrate types
Applications
- Opaque or transparent wafer incoming quality (ICQ) inspection
- Process monitor wafer particle and contamination inspection
- Unpatterned blanket photoresist, dielectric or metallic coated wafer defect inspection
- Subsurface defectivity inspection for transparent and semi-transparent films and substrates
- Glass carrier wafer defect and contamination inspection for advanced packaging
- Glass wafer defect and contamination inspection for microfluidics, microlens arrays for AR/VR/MR, flat optics, etc.

Do you have a PrimaScan system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
IVS 380 System
The IVS 380 System delivers overlay, CD and z-height metrology for advanced packaging, power, compound semi and MEMS, offering world class performance and flexibility to accommodate substrates of different sizes and thickness without hardware changes.

Product Overview
The IVS 380 is an optical overlay, CD & z-height metrology system designed for high volume manufacturing, with SMIF (200mm substrate) or FOUP (300mm substrate) load ports compatibility. It handles various substrates for advanced packaging, including Si, glass and CCL, and accommodates sizes of 200mm and 300mm.
Building on the IVS family’s 40 years of experience in CMOS, MEMS and compound semiconductor applications, the IVS 380 system possesses the versatility to tackle overlay, CD and z-height measurements for diverse substrates and layers. It measures critical dimensions in the xy plane and the vertical z-heights of features like RDL metal lines, posts and bumps. The optics enable focus on mostly transparent materials such as photoresists and rough surfaces such as electroplated copper.
Applications
- Critical Dimension
- On Product Overlay
- Specialty
Featured Markets
3D Demo
Enter your information below and we’ll send you a unique passcode to view our IVS 3D Demo.

Do you have an IVS 380 system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
Iris™ S System
The Iris S system is a versatile platform solution for the advanced packaging and specialty market, supporting 150mm, 200mm and 300mm wafers. It provides thin and thick film, OCD and wafer bow and film stress measurements.

Product Overview
The Iris S system delivers films metrology and advanced OCD capabilities for the specialty and advanced packaging segments. With a small footprint, it handles 150mm, 200mm, and 300mm wafer sizes, including thin, thick and bonded wafers. The system supports various materials such as Si, SiC, GaN and glass, addressing device-level challenges impacting performance and yield. Leveraging Onto’s Ai Diffract™ software, the Iris S system supports the most difficult on-wafer high value problems.
The Iris S system includes a dual-arm robot, high-precision stage, advanced pattern recognition, and high-speed focus for accurate positioning at high throughput. The dual channel optical architecture offers oblique incidence Mueller Matrix spectroscopic ellipsometry (MMSE) and normal incidence spectroscopic reflectometry (SR) in a broad wavelength range from UV to IR.
Based on Windows 10 OS and a 64-bit architecture, the Ai Diffract™ software interface and automation comply with SEMI standards. Onto’s model guided machine learning enables fast, flexible and robust film and OCD recipe setup.
Applications
- Thin, thick and ultra thick film thickness
- Trench/OCD metrology capabilities
- Optical properties and composition solutions
- Configurable for 6”, 8” and 12” wafer sizes
- High warped wafer handling and stress measurements
- Si, SiC, GaN and glass wafer handling
Featured Markets
Intelligent Line Monitoring & Control with Integrated Metrology
Enhance CMP process control with a connected metrology approach that feeds forward data from standalone OCD or films metrology to integrated metrology, connected through AI-driven analytical software. This approach, powered by advanced modeling and analysis tools, can deliver high-precision, high-throughput results—minimizing or eliminating the need for and cost of new TEM data and enabling accelerated time to solution, faster excursion detection, reduced cost and improved Cpk.

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
As semiconductor manufacturers push the boundaries of performance and functionality—driven by high-performance computing and AI applications—chemical mechanical planarization (CMP) processes increase in intensity complexity. New logic transistor designs, 3D NAND stacking, and DRAM integration introduce more CMP layers and tighter process windows.
Hybrid Bonding Process Control Solution
Hybrid bonding enables ultra-dense 3D memory interconnects with up to 1,000x more connections than microbumps. Achieving high yield requires stringent process control, including monitoring topography and detecting particles, cracks and voids. Measuring dishing in copper pads provides valuable insight into surface conditions. Together, these process control insights contribute to improved device reliability and performance.

Enabling In-Line Process Control for Hybrid Bonding Applications
As demand grows for high-performance computing (HPC) and AI-driven applications, manufacturers are turning to hybrid bonding to enable the ultra-dense 3D integration required for next-generation chip architectures. This advanced packaging technology presents significant process challenges. Surface preparation must be precisely controlled to eliminate particles, excess recess, and copper pad dishing, all of which can compromise bond quality. During pre-annealing, particle-induced gaps and wide bonding gaps can prevent proper wafer contact. Post-annealing, the formation of dielectric and metal voids introduces further risks to electrical performance and long-term reliability.

Do you have an Iris S system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
IMPULSE®+ System
The IMPULSE+ system is designed to deliver film measurement, fidelity and productivity in the CMP process module. Available as an integrated or standalone platform, it offers high sensitivity and accuracy.

Product Overview
An integrated metrology standard, the IMPULSE+ system offers high sensitivity and accuracy to CMP process excursions and enables device makers to establish APC control with high-accuracy feedback. The IMPULSE+ system works in conjunction with the Atlas® platform, facilitating cross-module process optimization and comprehensive fab-wide process control.
Based on a common optical design derived from our stand-alone Atlas® platform, the IMPULSE+ system shares superior deep ultraviolet (DUV) optics. This unique ecosystem can be leveraged to improve signal to noise ratio by applying spectra feedforward from the Atlas platform, further enhanced by AI-driven machine analytics. This combination affords CMP process engineers a potent arsenal of capability to manage excursions and drive process improvement (Cpk.).
The IMPULSE+ system is widely adopted across key steps in DRAM, 3D-NAND, CMOS image sensor and foundry/logic device manufacturing. challenging to measure.
Applications
- CMP
Intelligent Line Monitoring & Control with Integrated Metrology
Enhance CMP process control with a connected metrology approach that feeds forward data from standalone OCD or films metrology to integrated metrology, connected through AI-driven analytical software. This approach, powered by advanced modeling and analysis tools, can deliver high-precision, high-throughput results—minimizing or eliminating the need for and cost of new TEM data and enabling accelerated time to solution, faster excursion detection, reduced cost and improved Cpk.

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
As semiconductor manufacturers push the boundaries of performance and functionality—driven by high-performance computing and AI applications—chemical mechanical planarization (CMP) processes increase in intensity complexity. New logic transistor designs, 3D NAND stacking, and DRAM integration introduce more CMP layers and tighter process windows.

Do you have an IMPULSE+ system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields
IMPULSE® V System
The IMPULSE V system helps to advance CMP processing with enhanced wavefront technology and AI-driven analytics, delivering over 2X precision improvement and faster solutions, crucial for next-gen semiconductor manufacturing demands.

Product Overview
As wafer uniformity requirements tighten and vertical scaling increases, the need for CMP processing grows across market segments. Logic introduces new transistor designs and materials, DRAM incorporates new materials and process steps to planarize, and 3D NAND adds more decks, stacks and tiers.
The IMPULSE V system, available as an integrated or standalone platform, enhances film measurement fidelity and productivity for the CMP process module. With deep ultraviolet (DUV) optics and AI-driven machine analytics derived from our Atlas® platform, it works in conjunction with the Atlas® platform to provide CMP process engineers the capability to manage excursions and drive process improvement (Cpk.).
Advanced wavefront technology suppresses previous layer noise in complex structures. It provides feedback to improve long term repeatability. Designed for higher sampling, in-die/on-device and wafer edge measurements, the system offers improved reliability, higher throughput and over 2X precision improvement compared to the previous generation. Onboard AI-driven machine learning uses a signal-to-noise ratio for faster time-to-solution, addressing layers that were previously challenging to measure.
Applications
- CMP
Intelligent Line Monitoring & Control with Integrated Metrology
Enhance CMP process control with a connected metrology approach that feeds forward data from standalone OCD or films metrology to integrated metrology, connected through AI-driven analytical software. This approach, powered by advanced modeling and analysis tools, can deliver high-precision, high-throughput results—minimizing or eliminating the need for and cost of new TEM data and enabling accelerated time to solution, faster excursion detection, reduced cost and improved Cpk.

Enhancing CMP Process Control with Intelligent Line Monitoring & Integrated Metrology
As semiconductor manufacturers push the boundaries of performance and functionality—driven by high-performance computing and AI applications—chemical mechanical planarization (CMP) processes increase in intensity complexity. New logic transistor designs, 3D NAND stacking, and DRAM integration introduce more CMP layers and tighter process windows.
Hybrid Bonding Process Control Solution
Hybrid bonding enables ultra-dense 3D memory interconnects with up to 1,000x more connections than microbumps. Achieving high yield requires stringent process control, including monitoring topography and detecting particles, cracks and voids. Measuring dishing in copper pads provides valuable insight into surface conditions. Together, these process control insights contribute to improved device reliability and performance.

Enabling In-Line Process Control for Hybrid Bonding Applications
As demand grows for high-performance computing (HPC) and AI-driven applications, manufacturers are turning to hybrid bonding to enable the ultra-dense 3D integration required for next-generation chip architectures. This advanced packaging technology presents significant process challenges. Surface preparation must be precisely controlled to eliminate particles, excess recess, and copper pad dishing, all of which can compromise bond quality. During pre-annealing, particle-induced gaps and wide bonding gaps can prevent proper wafer contact. Post-annealing, the formation of dielectric and metal voids introduces further risks to electrical performance and long-term reliability.

Do you have an IMPULSE V system question? Let’s talk!
As your partner for innovative solutions, we’re always here for you.
Discover how our cutting-edge semiconductor solutions are engineered to meet your most complex challenges: delivering performance, reliability and innovation where it matters most.
Let’s Talk
"*" indicates required fields